میکروسکوپی پروبی روبشی از گرافن-بخش دوم

گرافن موضوع تعداد زیادی از تحقیقات نظری و عملی بوده است تا اینکه از سال 2004، هنگامی که از یک روش ساده و ظریف برای ساخت گرافن تک لایهای استفاده شد، زمینه برای انجام تحقیقات بسیار گسترده فراهم گردید. روشهای بسیار زیادی موازی با این روش برای ساخت گرافن توسعه یافته است. با آشکار شدن ویژگیهای ساختاری و الکترونیکی منحصربه فرد گرافن، مشخص گردید که روش میکروسکوپی پروبی روبشی یک روش جالب و فوقالعاده برای مطالعه این ترکیب است. در این مقاله مروری، روش میکروسکوپی پروبی روبشی و چگونگي استفاده از این روش بهعنوان یک ابزار ضروری برای درک خواص گرافن و تحقیقات گرافن در آینده، بررسي شدهاست.
این مقاله شامل سرفصلهای زیر است:
1- طیفسنجی، تعیین نقطه دیراک
1-1- الکترون – حفرههای کوچک
1-1-1- اندازه گیریهای SET
2-1-1- اندازهگیریهای STM روی SiO2
3-1-1- اندازهگیریهای STM روی h-BN
4-1-1- اندازهگیریهای SGM
2-1- پراش و نقصها
3-1-رژیم کوانتوم هال
4-1- کرنش و میدان شبه مغناطیسی
نتيجهگيري
1- طیفسنجی، تعیین نقطه دیراک
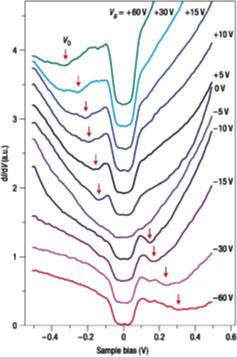
1-1- الکترون – حفرههای کوچک
1-1-1- اندازه گیریهای SET
2-1-1- اندازهگیریهای STM روی SiO2
این امر همانطور که در نقشههای LDOS شکل (2-ب) نشان داده شدهاست، باعث بهوجود آمدن الکترون و حفرههای کوچک در گرافن میشود. نواحی قرمز، مناطقی هستند که نقطه دیراک به سمت ولتاژ مثبت نمونه جابهجا شده و از اینرو، این نواحی حفره ـ آلاییده هستند. نواحی آبی با جابهجایی نقطه دیراک به ولتاژ منفی نمونه، الکترون ـ آلاییده هستند.
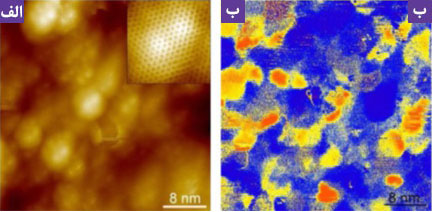
اندازهگیریهای STM همراه با تجزیه و تحلیل فضایی، همچنین میتواند در بررسی اثر امواج روی الکترون و حفره مورد استفاده قرار گیرد. محاسبات تئوری نشان میدهد که حالت موجدار بودن در گرافن موجب تغییر پتانسیل الکتروشیمیایی شده و باعث میشود که گرافن در نواحی الکترون ـ آلاییده به شدت خمیده شده و در نواحی حفره ـ آلاییده مسطح گردد. با استفاده از تصاویر توپوگرافی STM، خمیدگیهای گرافن اندازهگیری شده و جابهجاییهای پتانسیل الکتروشیمیایی مورد انتظار محاسبه شدند. با مقایسه نقشه فضایی این جابهجایی با نقشه dI/dV که مستقیماً با STM ثبت شدهاست، مشاهده میشود که همبستگی بین خمیدگی و چگالی موضعي ترازها وجود ندارد. این مقایسه آشکار میکند که در نمونههای موجود، موجهای گرافن منبع اصلی ناهمگنی بار نیستند. این امر مدارک بیشتری را برای این ایده فراهم میکند که پراش دور برد ناشی از ناخالصیهای تصادفی باردار نقش مهمی را در ایجاد الکترون و حفره بازی میکند.
با استفاده از طیفسنجی انسداد کلومبی، نوسانات پتانسیل محلی را میتوان با توان تفکیک فضایی بيشتري ترسیم نمود. با استفاده از یک نانوذره طلا در نوک سوزن STM، یک حسگر بار ایجاد میشود كه ميتوان سطح نمونه را با آن روبش كرد. با دو مانع تونلی، سوزن به نانوذره و نانوذره به گرافن، میتوان در نواحی مختلف گرافن به پدیده انسداد کلومبی دست یافت. پیکهای CB ثبت شده در طیفسنجی dI/dV، بهویژه بهعلت نوسانات پتانسیل در گرافن منحرف میشوند. همانطور که در شکل (3) مشاهده میشود، این پیکها در نقشه dI/dV بهصورت حلقههایی که با تغییر ولتاژ سوزن تغییر میکنند، نشان داده میشوند. ویژگی برجسته این مطالعه، توان تفکیک بیسابقه (تقریباً 1 نانومتر) در نقشههای پتانسیل منطقهای است که یک پیشرفت بسیار بزرگ در گزارشهای اخیر 150 نانومتر از اندازهگیریهای SET است.
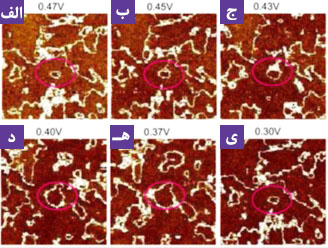
3-1-1- اندازهگیریهای STM روی h-BN

4-1-1- اندازهگیریهای SGM
مطالعات SGM در حالت تماسی با استفاده از یک نانوسیم فلزی پوشش داده شده با عایق بهعنوان گیت روبش، روی ترانزیستورهای گرافنی اثر میدان انجام شدهاست. نواحی الکترون ـ آلاییده و حفره ـ آلاییده با SGM تصویربرداری شدهاند. مشخص شدهاست که آلایندهاي خارجي از محلهای تماس، نقصها و پسماندهای مقاوم در نوسانات فضایی چگالی حامل شرکت میکنند.

2-1- پراش و نقصها
تصاویر STM گرافن ورقهای روی SiO2، نقصهای نقطهای را نشان میدهد. این نقصها، همانطور که در شکل (6-الف) مشاهده میشود، باعث پراکندگی کوتاه برد میشوند. نقشههای dI/dV ثبت شده در Ef، با توجه به پراکندگی الکترونهاي ناشی از نقصهای کوتاه برد، الگوهای تداخلی را نشان میدهند. شکل (6-ب) تبدیل فوریه این نقشه را ترسیم کرده و الگوی تداخلی

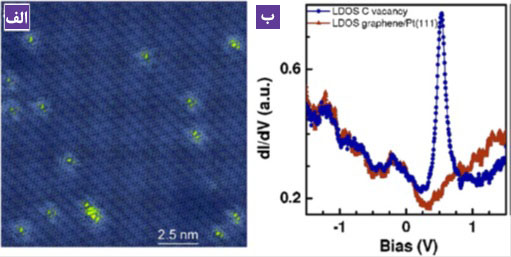
گرافن همبافته نیز دارای موج است. لایه حائل کربنی نیز همواره در لایه میانی SiC- گرافن وجود دارد. این لایه، گرافن را از پایه جدا میکند. بهدلیل برهمکنش ضعیف بین لایه گرافن و لایه حائل کربن، موجهای 6×6 SiC بهوجود میآیند. این موجها دارای دامنه 0/04nm و طول موج 1/9nm است.

همچنین نقصهای شبکهای گرافن دو لایهای روی SiC با استفاده از STM تصویربرداری شدهاند. نقشه dI/dV که بهصورت همزمان با تصویر توپوگرافی ثبت شدهاست، الگوهای تداخلی که هم از پراکندگی دور برد و هم از پراکندگی کوتاه برد ناشی میشود را نشان میدهد. در مورد این موضوع بعداً در بخشي جداگانه در طیفسنجی دو لایهای بحث خواهد شد.
3-1-رژیم کوانتوم هال
نخستین بار، QHE در گرافن ورقهای روی SiO2 و در اندازهگیریهای انتقالی روی نمونهای بهصورت الکترود نواری شکل هال مشاهده شد. در میدان مغناطیسی بسیار بالا مقاومت طولی Rxx ناپدید میشود، در حالی که مقاومت عرضی Rxy همانطور که در QHE انتظار میرود، حالت مسطح را نشان میدهد.
بررسیهای سطوح لاندو (LL) در گرافن با STM، یک ویژگی مهم بنیادی گرافن را نمایان میسازد، که حالت انرژی صفر در گرافن، LL0، است. سطوح لاندو در انرژی بهصورت نابرابر تقسیم شدهاند و هم با ریشه دوم میدان مغناطیسی و هم با شاخص LL تغییر میکنند. اندازهگیریهای طیفسنجی تونلی(STS) در 4/3K روی 1±10 لایه گرافنی که روی صفحه کربنی 4H-SiC(0001⁻) حكاكي شده با هیدروژن نشانده شدهاست، انجام گردید. میدان مغناطیسی از 1T تا 8T تغییر داده شد. در شکل (17)، dI/dV که بهصورت تابعی از انرژی در میدان مغناطیسی 5T ترسیم شده، نشان داده شدهاست. در این جا، پیک LL0 در 7meV و شکافهای بین LL، LL0، LL1 رفتار فرمیون بدون جرم دیراک را تأیید میکند. این امر همچنین نشان میدهد که بالاترین لایه گرافن بهطور مؤثری از لایههای دیگر و نیز از لایه زیرین پایه SiC جدا شدهاست.
علاوهبر گرافن ورقهای با پایه SiO2 و گرافن همبافته با پایه SiC، گرافن میتواند روی پایه گرافیت نیز مطالعه شود. این نوع از گرافن نخستین بار توسط لی و همکارانش بررسی شد. آنها رفتار فرمیونهای بدون جرم دیراک و فرمیونهای عظیم دیراک را درسطح HOPG (گرافیت پیرولیتیک بسیار جهت یافته) با اندازهگیریهای STS در 4/4K و میدانهای مغناطیسی بالاتر از 12T بررسی کردند. برای فرمیونهای بدون جرم دیراک در گرافن تک لایهای، انرژی LL با

در مطالعه دیگری روی نمونههای گرافن مشابه، تصاویر STM از جدا شدن ورقه گرافن تهیه شدهاست که شبکه هگزاگونالی بالاترین لایه و شبکه مثلثی در لایه زیر بالاترین لایه را نشان میدهد. همانطور که در شکل (3) مقاله بخش اول نشان داده شدهاست، هر دو لایه با مرزی طولانی از سطح گرافیت جدا شدهاند. در یک بررسی جزئیتر طیفسنجی که در مورد جدایی لایه گرافن انجام شدهاست (شکل 10-الف)، همه نشانههای ویژه گرافن مانند طیف خطی dI/dV مشاهده میشود. شکل (10-ج) اثر تغییر میدان مغناطیسی از 0T تا 10T را ترسیم میکند. با افزایش میدان، طیف رشته پیکهای به خوبی تعریف شده LL را نشان میدهد. شکل (10-د) رسم پیکهای انرژی بهصورت تابعی از را نشان میدهد كه همانگونه که انتظار میرود، اعداد در یک خط مستقیم قرار میگیرند. نشانهها به پیکها مربوط هستند. خط با رابطه
n=0, ±1, ±2, متناسب است. ED انرژی نقطه دیراک و νF انرژی فرمی است.

4-1- کرنش و میدان شبه مغناطیسی
از گرافن رشد یافته روی صفحه Pt(111) برای سنجش این پیشبینی اساسی استفاده شد، که اعوجاج شبکه گرافن موجب بهوجود آمدن میدان شبه مغناطیسی میشود. اعمال میدانی با تقارن مثلثي شكل، میتواند میدان شبه مغناطیسی Bs با بزرگی بیش از دهها تسلا بهوجود آورد. نیروی کرنش از میدان مغناطیسی ایجاد میشود که میتوان با استفاده از رابطه زیر بهدست آورد:
که در آن h: ارتفاع، l: عرض، a: مرتبه طول پیوند C-C، شارش کوانتومی و β: مربوط به تغییرات دامنه جهشی است که بین نزدیکترین اتمهای کربن مجاور روی میدهد. برای گرافن مقدار β بین 2 و 3 است، و برای شارش در موج در یک صفحه اعوجاج یافته گرافن کاربرد دارد.
با رشد تک لایه پوششی گرافن در UHV با قرار دادن Pt(111) در معرض اتیلن و سپس آنیل نمودن آن، گرافن اعوجاج یافته با حبابهای نانویی روی سطح Pt(111) بهوجود میآید. نانو حبابها بهصورت ساختاری به بلندی 2-0/3 نانومتر و عرض 10-4 نانومتر به تصویر کشیده شدهاند. شکل (11-الف) توپوگرافی نانو حبابها را نشان میدهد. طیف dI/dV که از روی یک نانوحباب تهيه شدهاست، پیکهایی را نشان میدهد که با فاصله بیش از 100meV جدا شدهاند. این پیکها به سطوح لاندو (LL) که از کرنش ناشی از میدان مغناطیسی بهوجود آمدهاند، نسبت داده میشوند. این پیکها از رفتار مقیاسپذیری که برای فرمیونهای بدون جرم دیراک در تک لایه گرافن انتظار میرود، پیروی میکنند. مقدار Bs از فاصله پیک در نقاط متفاوت روی حباب بهدست میآید. در مرکز نانوحباب، مقدار Bs از 300T تا 400T تغییر میكند. شکل (11-ب) وابستگی فضایی میدان مغناطیسی موثر را نشان میدهد. در لبههای نانوحباب، تغییرپذیریهای بیشتری مشاهده میشود.

نتيجهگيري
منابـــع و مراجــــع