آموزش پیشرفتهآموزش نانو
اصول و مفاهیم طیفسنج فوتوالکترون پرتو ایکس – بخش اول

طیفسنجی فوتوالکترون پرتو ایکس، روشی بهمنظور بررسی سطح نمونه تا عمق حدود 100 انگستروم از نظر آنالیز عنصری، ترکیب شیمیایی و تعیین حالت پیوندی است. با توجه به این نکته که انرژی جنبشی الکترونهای گسیل شده بر اثر یونیزاسیون یک ماده با فوتون تکفام پرتو ایکس مورد اندازهگیری قرار میگیرد، طیف فوتوالکترونهای آن ماده، بر مبنای تعداد الکترونهای گسیلی برحسب انرژی ترسیم میشود.
انرژی فوتوالکترونهای هر نمونه آزمون، مشخصهی اتمهای تشکیل دهندهی آن است، بنابراین اندازهگیری انرژی جنبشی این فوتوالکترونها معیاری برای تعیین عناصر موجود در آن نمونه است. شناسایی حالت شیمیایی و الکترونی عناصر ماده مانند تمایز قائل شدن بین اشکال سولفاتی و سولفیدی عنصر گوگرد از انحرافات اندکی در انرژی جنبشی و اندازهگیری میزان غلظت نسبی آن عنصر با توجه به شدت فوتوالکترونهای مربوطه امکانپذیر است. از این روش در طیف وسیعی از صنایع چون هوافضا، الکترونیک، ارتباطات و حمل و نقل و غیره میتوان بهره برد.
این مقاله شامل سرفصلهای زیر است:
1- مقدمه
2- اصول فیزیکی فوتوالکترون پرتو ایکس (XPS)
3- تئوری فوتوالکترون پرتو ایکس (XPS)
4- نمودار طیفسنجی XPS
1-4- تفسیر زمینهی طیف XPS
1-1-4- اثر جابجایي شیمیایی روی طیف فتوالکترون پرتو ایکس
نتیجهگیری
این مقاله از مجموعه مقالات فصل نامه شبکه آزمایشگاهی فناوریهای راهبردی سال 2017 شماره 20 برگرفته شده است. برای دسترسی به مراکز خدمات دهنده آنالیز طیفسنج فوتوالکترون پرتو ایکس (XPS) بر روی دکمه زیر کلیک کنید.
1- مقدمه
امروزه روشهاي آنالیز و شناسایی مواد، بسیار حائز اهمیت است. خواص فیزیکی و شیمیایی یک محصول به نوع مواد اولیه و ریزساختار آن بستگی دارد. بنابراین، بهمنظور شناسایی ویژگیهاي یک ماده برای انجام پژوهش و نیز کنترل کیفیت محصولات صنعتی، نیاز به روشها و تجهیزات شناسایی است. روشهاي آنالیز را میتوان به سه دستهی کلی تقسیمبندي نمود:
- آنالیز عنصري: در این روش تنها نوع عنصر و یا مقدار آن مشخص شده ولی ساختار بلوری عنصر یا ماده تعیین نمیشود. نام دیگر این روش آنالیز شیمیایی است.
- آنالیز فازي: در این نوع آنالیز، ساختار بلوری یا کانیهاي موجود در ماده مشخص میشود.
- -آنالیز ریزساختاري: در این روش شکل، اندازه و توزیع فازها مورد بررسی قرار میگیرد. این ویژگیها اثر مهمی بر خواص نهایی ماده دارند.
علاوه بر سه دستهی فوق، دو روش دیگر، آنالیز سطح و آنالیز حرارتی نیز وجود دارند که به علت اهمیت کاربردي بهصورت جداگانه و مستقل بررسی میشوند. یکی از آنالیزهایی که براساس برهمکنش بین پرتوی ایکس و نمونه شکل گرفته است، آنالیز طیفسنجی فوتوالکترون پرتو ایکس است. XPS يك آناليز قدرتمند براي ارزيابي سطح نمونه به شمار ميرود كه اولين بار در سال 1887 توسط هاینریش رودولف هرتز بر مبناي اثر فوتوالكتريك بنا شد.
در سال 1905، آلبرت اینشتین اثر فوتوالکتریک را با توصیف سادهی ریاضی توضیح داد که منجر به جایزهی نوبل در فیزیک شد. روش XPS بر طبق نظر انیشتین در مورد اثر فوتوالکتریک توسعه پیدا کرد که در آن از مفهوم فوتون برای توصیف خروج الکترون از سطح در اثر تابش بهره برد و در سال 1907، اینز اولین طیف XPS را رسم کرد. در اواسط دههی 1960 پروفسور سیگبان و گروه تحقیقاتیاش طیفسنجی فوتوالکترون پرتو ایکس را با عنوان روش XPS، بهعنوان روش تحلیلی شناخته شده، توسعه دادند؛ او اصطلاح طیفسنجی الکترونی را برای تجزیه و تحلیل شیمیایی ابداع کرد و در سال 1981، جایزهی نوبل در فیزیک به پروفسور سیگبان برای توسعهی روش XPS اهدا شد.
آناليز XPS، در حقيقت يك روش شیمیایی کمّی و کیفی است كه در آن سطح نمونهی جامد و قسمتی از عمق نمونه تحت تاثیر بمباران یونی قرار گرفته و نوع و تركيب شيميايي عناصر موجود در سطح نمونه قابل استخراج است. همچنین شناسایی حالت شیمیایی گونههای سطحی (از جمله حالت اکسایش عنصر) نیز از قابلیتهای این آنالیز است. این دستگاه در مراکز تحقیقاتی و واحدهای آزمایشگاهی صنایع مورد استفاده قرار میگیرد [1 – 6].
در سال 1905، آلبرت اینشتین اثر فوتوالکتریک را با توصیف سادهی ریاضی توضیح داد که منجر به جایزهی نوبل در فیزیک شد. روش XPS بر طبق نظر انیشتین در مورد اثر فوتوالکتریک توسعه پیدا کرد که در آن از مفهوم فوتون برای توصیف خروج الکترون از سطح در اثر تابش بهره برد و در سال 1907، اینز اولین طیف XPS را رسم کرد. در اواسط دههی 1960 پروفسور سیگبان و گروه تحقیقاتیاش طیفسنجی فوتوالکترون پرتو ایکس را با عنوان روش XPS، بهعنوان روش تحلیلی شناخته شده، توسعه دادند؛ او اصطلاح طیفسنجی الکترونی را برای تجزیه و تحلیل شیمیایی ابداع کرد و در سال 1981، جایزهی نوبل در فیزیک به پروفسور سیگبان برای توسعهی روش XPS اهدا شد.
آناليز XPS، در حقيقت يك روش شیمیایی کمّی و کیفی است كه در آن سطح نمونهی جامد و قسمتی از عمق نمونه تحت تاثیر بمباران یونی قرار گرفته و نوع و تركيب شيميايي عناصر موجود در سطح نمونه قابل استخراج است. همچنین شناسایی حالت شیمیایی گونههای سطحی (از جمله حالت اکسایش عنصر) نیز از قابلیتهای این آنالیز است. این دستگاه در مراکز تحقیقاتی و واحدهای آزمایشگاهی صنایع مورد استفاده قرار میگیرد [1 – 6].
2- اصول فیزیکی فوتوالکترون پرتو ایکس (XPS)
- پدیدهی فوتوالکتریک
زمانی که ماده با نور با انرژی لازم برهمکنش داشته باشد، یونیزاسیون رخ خواهد داد. XPS از پدیدهی فوتوالکتریک، بهمنظور آنالیز ساختار الکترونی ماده استفاده میکند. XPS نوعی طیفسنجی است که در پی تابش پرتوهای ایکس به نمونه، انرژی فوتوالکترونهای حاصل را اندازهگیری میکند (شکل (1)).

انرژی پرتو ایکس هر دستگاه XPS به منبع تولیدی پرتو ایکس آن بستگی دارد (شکل (2)).
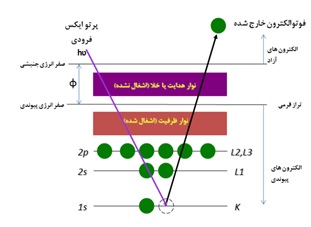
پرتو ایکس با انرژی کافی به سطح نمونه برخورد میکند و الکترون از مدارهای داخلی (مدار K) خارج میشود (شکل(3)).

تابش به سطح نمونه، با هدف قرار دادن الکترونهای نزدیک به هستهی اتم، انجام میشود. نفوذ پرتوی ایکس به نمونه در حد میکرومتر است اما فقط سیگنال الکترونهای بهدست آمده از عمق 10-100 آنگستروم از نمونه، مفید است. بهطور معمول، فوتونهای تک انرژی به نمونه میتابد. در منبع پرتو ایکس MgKa فوتونهایی با انرژی 1253/6 الکترون ولت و یا در AlKa فوتونهایی با انرژی 1486/6 الکترون ولت تولید میشوند. در (شکل (4)) پرتوهای پرتو ایکس تک انرژی آمده است.
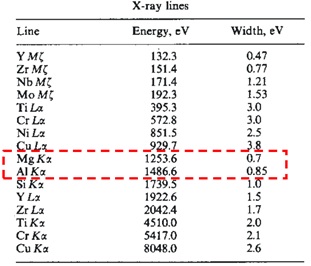
پرتو ایکس به الکترون اطراف هستهی اتمها در نمونه نفوذ میکند. برخی الکترونها بدون هیچ مشکلی باز میگردند و دارای انرژی جنبشی که از ویژگیهای عناصر بوده، هستند. دیگر الکترونها که از لایههای درونی میآیند، با الکترونهای دیگر از لایههای بالایی برخورد میکنند. انرژی الکترونهای پایینتر کمتر خواهد بود. آنها به میزان نویز ایجاد شده در طیف کمک خواهند کرد. در واقع سیگنال نویز از الکترونهایی که با دیگر الکترونها از لایههای مختلف برخورد میکنند، ایجاد میشود، این برخورد باعث کاهش انرژی الکترون خواهد شد.
3- تئوری فوتوالکترون پرتو ایکس (XPS)
سطح مادهی هدفی كه در محيط خلاء قرار گرفته، تحت تابش پرتو ايكس (با انرژي 2000-200 الكترون ولت) قرار ميگيرد و در نتيجهی اين برخورد، فعل و انفعالات زیر رخ ميدهد: يك فوتون پرتو ايكس به يك الكترون واقع در ترازهاي داخلي برخورد ميكند. در مرحلهی بعد، انرژي فوتون فرودي به الكترون هدف انتقال مييابد. الكترون هدف با دريافت مقدار انرژي كافي از اتم جدا شده و به سمت بيرون سطح نمونه گسيل ميشود. يك فوتوالكترون با انرژي جنبشي مشخص ايجاد ميشود. براساس مقادير مختلف انرژي جنبشي، فوتوالكترونها از هم تفكيك شده و سپس فوتوالكترونهاي تفكيك شده شمارش میشوند و بر اين اساس، غلظت اتمها و عناصر بدست ميآيد. انرژی کوانتومی پرتو ايكس فرودی (E=hʋ)، از حاصل ضرب فرکانس پرتو (اینجا فرکانس پرتو ایکس) در ثابت پلانک بدست میآید. از آنجا که انرژی پرتو ایکس تابانده شده مشخص است، میتوان انرژی الکترون گسیل شده را، كه همان انرژي جنبشي فوتوالكترون خروجي (KE) است، بدست آورد. در نهايت انرژي پیوندي الكترون از رابطهی قانون کار رادرفورد،كه اولين بار ارنست رادرفورد در سال 1914 ارائه داد، قابل محاسبه است. بنابر این بهصورت ساده داریم:
hν=KE+BE+Φ
- انرژی پیوندی: میزان انرژی لازم برای جدایی یک الکترون از یک اتم است. این انرژی، مشخصهی هر اوربیتال اتمی یک عنصر است. به طوری که الکترونهایی که در لایههای مختلف اوربیتالی یک اتم قرار گرفتهاند، انرژی پیوندی متفاوتی دارند.
- انرژی جنبشی (KE): میزان انرژی که یک ذره به علت حرکت دارد که این انرژی با استفاده از این دستگاه اندازهگیری میشود.
- تابع کار طیفسنج (و نه ماده) (Φ): کمترین میزان انرژی لازم بهمنظور جدایی یک الکترون از ماده به خارج با انرژی جنبشی صفر است.
- تراز فرمی: ترازی که در آن میزان انرژی پیوندی الکترونها با هستهی اتم، صفر است.
انرژی پرتو ایکس تابیده شده به ماده، صرف غلبه بر انرژی پیوندی با رساندن آن به تراز فرمی (BE)، سپس غلبه بر تابع کار (Φ) و در نهایت انرژی جنبشی لازم (KE) با توجه به سرعتی که الکترون کسب کرده، خواهد شد. در نتیجه اگر بتوانیم میزان انرژی جنبشی کسب شده فوتوالکترونها بر اثر تابش پرتو ایکس را محاسبه کنیم و از آنجا که دادههای لازم در مورد انرژی پرتو ایکس و تابع کار را از ابتدا میدانیم، به راحتی انرژی پیوندی آن الکترون قابل محاسبه است و بر این اساس میتوان جایگاه اولیهی الکترون ردیابی شده را تعیین کرد. به بیان ساده، انرژی جنبشی اندازهگیری شده برابر با رابطهی زیر خواهد بود:
KE= hν-(BE+Φ)
در نتیجه داریم:
BE= hν-(KE+Φ)
تابع کار برای نمونههای رسانا به دلیل همراستا شدن سطوح فرمی نمونه و طیفسنج، تنها برابر با تابع کار طیفسنج است. ولی برای نمونههای غیررسانا، به علت تجمع الکترونها در سمت طیفسنج و بالا رفتن سطح فرمی طیفسنج، تغییری خواهد کرد. برای رفع این مشکل، از ماکزیمم مشخصهی الکترونهای لایه 1s کربن، C 1s، برای کالیبره نمودن دادهها استفاده میشود. انرژی استاندارد C 1s برابر با 285 الکترون ولت است. در نتیجه در مورد نمونههای نارسانا یا نیمه رسانا، پس از جمعآوری داده، طیف را به اندازهای شیفت میدهند که ماکزیم مشخصهی C 1s برابر با 285 الکترون ولت شود و بدین طریق اختلاف سطوح فرمی طیفسنج و نمونه به دلیل تجمع الکترونها در سمت طیفسنج را میتوان از بین برد [10].
4- نمودار طیفسنجی XPS
در نمودار XPS پیکها تیز هستند؛ البته ممکن است پیک الکترونهای اوژه نیز مشاهده شود که بهطور معمول پیکهای مربوطه پهن هستند. در شکل (5) هر پیک نشاندهندهی الکترون در یک انرژی خاص بوده که از ویژگیهای عناصر است.
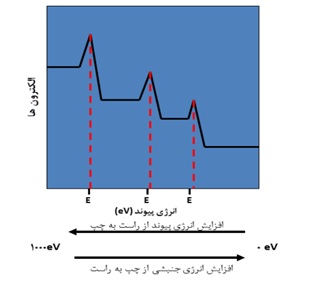
1-4- تفسیر زمینهی طیف XPS
پرتو ایکس به الکترون لایههای داخلی نمونهی بالک ضربه میزند. این الکترون با الکترون دیگر از لایههای بالایی برخورد خواهد کرد و انرژی آن کاهش مییابد که منجر به تولید نویز میشود.
در انرژی جنبشی کمتر، میزان نویز با انرژی پیوندی افزایش مییابد که این مربوط به مجموع نویزهای گرفته شده از آغاز آنالیز است (شکل (6)).
در انرژی جنبشی کمتر، میزان نویز با انرژی پیوندی افزایش مییابد که این مربوط به مجموع نویزهای گرفته شده از آغاز آنالیز است (شکل (6)).

یک طیف XPS، نموداری از تعداد الکترونهای ردیابی شده بر واحد زمان (محور عرضی نمودار) بر حسب انرژی پیوندی الکترونها (محور افقی) در مادهی مورد آزمایش است. هر عنصری در این نمودار، چند ماکزیمم منحصر به فرد را دارد، که مشخصهی آن عنصر است. وجود ماکزیمم متعلق به هر عنصر در طیف بدست آمده از آنالیز یک ماده، گویای وجود آن عنصر در سطح مادهی مورد آزمایش است. ماکزیممهای مشخصه هر عنصر، با چگونگی آرایش الکترونها در اتم آن عنصر، مرتبط است و میتوان اطلاعاتی از موضع الکترونهای ردیابی شده در لایههای الکترونی (بهطور مثال، 1s، 2s، 2p، 3s، 3p، 3d، 4s و غیره) بدست آورد. هر چه میزان انرژی جنبشی اندازهگیری شده یک الکترون بیشتر باشد، گویای این واقعیت خواهد بود که انرژی پیوندی آن کمتر بوده، لذا به لایههای اربیتالی بیرونیتر تعلق داشته است؛ بنابراین، الکترونهای لایههای داخلی، با انرژی جنبشی کمتری ردیابی خواهند شد و ماکزیمم مشخصهی آنها در نمودار طیفسنجی، در سمت انرژیهای بالای انرژی پیوندی خواهند بود. هر عنصر، دستهای از ترازهای داخلی منحصر به فرد خود را دارد و انرژی پیوندی این ترازها میتواند مثل اثر انگشت برای شناسایی آن عنصر بکار رود؛ انرژی یک زیرلایه الکترونی، با افزایش عدد اتمی Z، افزایش مییابد. نمودار انرژی پیوندی برحسب ساختار اتمی و ساختار الکترونی در شکل (7) آورده شدهاست.

تعداد الکترونهای ردیابی شده در هر ماکزیمم مشخصهی یک عنصر، با میزان آن عنصر در سطح مادهی مورد آزمایش ارتباط مستقیم دارد. برای بدست آوردن مقادیر درصدی، هر سیگنال خام XPS باید با تقسیم تعداد الکترونهای شدت سیگنال (تعداد الکترونهای ردیابی شده) بر فاکتور حساسیت نسبی نرمال نمودن مقادیر با توجه به تمامی عناصر ردیابی شده صورت گیرد. نتایج درصدی حاصل، مقادیر مربوط به عنصر هیدروژن را شامل نمیشود.
1-1-4- اثر جابجایي شیمیایی روی طیف فتوالکترون پرتو ایکس
اثر جابجايي شيميايي نخستين بار توسط سيگبال در اوايل دههی 50 ميلادي كشف شد. بر طبق اين پديده انرژي پيوندی الكترون مدارهاي داخلي يك اتم بستگي به محيط شيميايي اطراف آن يا به عبارت ديگر بستگي به پيوند اتمي آن دارد. اثر جابجايي شيميايي اطلاعات بسیار مفیدی را از محيط شيميايي اطراف اتم آشكار ميكند. در واقع توانايي اصلي روش ESCA يا XPS بيشتر از آن كه در آناليز سطح باشد در تعيين محيط شيميايي عنصرهاي موجود در نمونه است. مقدار جابجايي شيميايي در مواد گوناگون متفاوت است و ميتواند از 0/5 تا 15 الكترون ولت تغيير كند. در دستگاه XPS امكان بمباران سطح نمونه و لايهبرداري به كمك تاباندن پرتویي از يونهاي يك گاز مثل آرگون وجود دارد؛ در اين حالت با لايهبرداري از سطح مورد بررسی در عمق نمونه انجامپذير خواهد شد و تغيير تركيب شيميايي از سطح به عمق را ميتوان بررسي كرد. تشكيل تركيبهاي گوناگون بهصورت يك لايهی نازك در سطح مواد به كمك روش XPS به آساني قابل بررسي است در حالي كه با روشهاي ديگر اين كار امكانپذير نيست.
براي يك جامد و بسته به نوع ماده، انرژي فوتوالكترون و زاويهی اندازهگيري (نسبت به سطح)، XPS از 2 تا 25 لايهي اتمي را پويش ميكند. قابلیتهای ويژهي XPS در آناليزهاي عنصري نيمه كمي روي سطح بدون استانداردها و آناليز حالتهاي شيميايي، براي مواد مختلف از مواد بيولوژيكي تا متالورژيكي عنوان میشود. براي درك بهتر اين پديده طيف XPS تركيب پلي متيل متا كريلات در شكل (8) نشان داده شدهاست.
براي يك جامد و بسته به نوع ماده، انرژي فوتوالكترون و زاويهی اندازهگيري (نسبت به سطح)، XPS از 2 تا 25 لايهي اتمي را پويش ميكند. قابلیتهای ويژهي XPS در آناليزهاي عنصري نيمه كمي روي سطح بدون استانداردها و آناليز حالتهاي شيميايي، براي مواد مختلف از مواد بيولوژيكي تا متالورژيكي عنوان میشود. براي درك بهتر اين پديده طيف XPS تركيب پلي متيل متا كريلات در شكل (8) نشان داده شدهاست.

با توجه به شکل (8) و دادههای جدول شکل (9) اثر جابجايي شيميايي مربوط به محيط شيميايي اطراف اتم کربن و اکسیژن در ترکیب پلي متيل متا كريلات بهصورت پیکهای جداگانه با جابهجایی انرژی پیوند قابل مشاهده است. در واقع تغییر در انرژی اتصال یک الکترون از هسته یک عنصر به علت تغییر در پیوند شیمیایی آن عنصر ایجاد میشود [7].

نتیجهگیری
XPS یک روش آنالیز عنصری بوده که در تهیهی اطلاعات حالت شیمیایی عناصر مشخص شده مانند تمایز قائل شدن بین اشکال یونی یک عنصر، منحصر به فرد است. این فرآیند از طریق تابش پرتوهای تک انرژی ایکس که منجر به انتشار فوتوالکترونهایی که انرژی آنها مشخصهی عناصر موجود در حجم نمونهبرداری شدهاست، انجام میگیرد. در این روش، سطح نمونه با پرتو ایکس تک انرژی بمباران میشود و فوتوالکترونهای پر انرژیترِ تولید شده موفق به فرار از ماده میشوند. این فوتوالکترونها پس از ارسال به تحلیلگر انرژی و تعیین انرژی جنبشی آنها، به آشکارساز هدایت میشوند تا تعداد فوتوالکترونهای تولیدی با انرژی جنبشی مشخص شمارش شوند. به علت تکفام بودن پرتو ایکس و قرار داشتن الکترونها در سطوح گسسته انرژی، انرژی الکترونهای جدا شده نیز مقادیر گسستهای دارند. الکترونهایی که از سطح ماده خارج میشوند، در برخوردهای متوالی، بخشی از انرژی خود را از دست میدهند و طیف کلی این آنالیز، مجموعهای از پیکهاست که روی یک زمینه قرارگرفتهاند. در نهایت این اطلاعات بهصورت تعداد فوتوالکترونها بر حسب انرژی پیوندی رسم میشوند. شرط اصلي براي انجام آناليز XPS، وجود خلاء بسیار زياد در داخل محفظهی خلاء است. اين نوع آناليزها جزء سامانههاي گران قیمت به شمار ميروند؛ از اين رو، تعداد اين سامانهها نسبت به ديگر سامانههاي آناليز، كمتر است.
منابـــع و مراجــــع
۱ – Einstein, A. Ann. Phys. Leipzig (1905), 17, 132-148.
۲ – Siegbahn, K.; Edvarson, K. I. Al (1956). “β-Ray spectroscopy in the precision range of 1 : 1e6”. Nuclear Physics.
۳ – C. Nordling E. SokolowskiK. Siegbahn, Phys. Rev. (1957), 105, 1676.
۴ – D.W. TurnerM.I. Al Jobory, “Determination of Ionization Potentials by Photoelectron Energy Measurement”. J. Chem. Phys. (1962), 37, 3007.
۵ – S. Hagström, C. NordlingK. Siegbahn, Phys. Lett. (1964), 9, 235.
۶ – J.F. Moulder, W.F. Stickle, P.E. Sobol, K.D. Bomben (1992), Handbook of X-ray Photoelectron Spectroscopy, Perkin-Elmer Corp, Eden Prairie, MN.
۷ – D. R. Vij, Handbook of Applied Solid State Spectroscopy, Springer, New York, (2006).
۸ – University of Illinois at Urbana-Champaign [groups.mrl.illinois.edu/nuzzo/0-ppt/XPS Class 99.pps].
۹ – A. T. Hubbard, The Handbook of Surface ImagingVisualization, CRC Press, Boca Raton, Florida, (1995).
۱۰ – Watts, J. F., Wolstenholme, J. (2003), “An Introduction to Surface Analysis by XPSAES”, 2nd Edition, New York, Wiley.
۱۱ – X-ray Photoelectron Spectroscopy, D. Torres, University of Texas at El Paso [nanohub.org/resources/2011/download/x-ray photoelectron spectroscopy (xps).ppt].
۱۲ – XPS Spectra, CasaXPS www.casaxps.com/help_manual/manual_updates/xps_spectra.pdf
۱۳ – https://en.wikipedia.org/wiki/X-ray_photoelectron_spectroscopy.
۱۴ – University of Western Ontario [mmrc.caltech.edu/SS_XPS/XPS_PPT/XPS_Slides.pdf].
۱۵ – Crist, B.V. (2004), “Handbooks of Monochromatic XPS Spectra”, USA, published by XPS International LLC.
۱۶ – D. Briggs (2003), XPS: Basic Principles, Spectral FeaturesQualitative Analysis, in: D. Briggs, J.T. Grant (Eds.), Surface Analysis by AugerX-ray Photoelectron Spectroscopy, IM Publications, Chichester, 31-56.