بررسي مواد در مقياس نانو با استفاده از ميكروسكوپ ظرفيتي روبشي
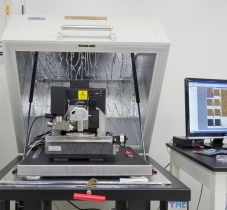
ميكروسكوپي ظرفيتي روبشي، روشي غيرمخرب است كه براي شناسايي و بررسي نمونههاي نيمههادي مورد استفاده قرار ميگيرد. یکی از كاربردهاي تجاری ميکروسکوپ ظرفيتی روبشی، تصويربرداری از ناخالصیها در قطعات نيمههادي است. اين ميكروسكوپ ميتواند براي اندازهگيري چگالي حاملهاي بار با دقتی در مقياس نانومتر نیز استفاده شود. توانایی این روش در تصویربرداری از توزیع بار با توان تفكيك و حساسیت بسیار بالا سبب شدهاست كه بهعنوان روشي با ارزش براي شناسايي نانومواد محسوب شود.
این مقاله شامل سرفصلهای زیر است:
1- مقدمه
2- اصول كار ميكروسكوپ ظرفيتي روبشي
3- آمادهسازی نمونه
4- ویژگی پروبهای SCM
نتیجهگیری
1- مقدمه
در ميكروسكوپ ظرفيتي روبشي از يك پروب رساناي بسيار تيز (اغلب پروب سیلیکونی اسیدشویی شده با روکش پلاتين – ايريديوم يا كبالت – كروم) استفاده ميشود. وقتي پروب به سطح نزديك ميشود، در مجاورت سطح، ولتاژ بایاس (AC) اعمال میشود تا اختلاف ظرفيتي را در نمونه ایجاد کرده و با استفاده از يك حسگر ظرفيتي، فركانس رزونانس را در مقياس (GHz) شناسایی کند. سپس در حالیکه ارتفاع سوزن بهوسیله سیستم بازخورد نیروی تماسی کنترل میشود، سوزن، سطح نمونه نیمههادي را در دو بعد روبش میکند.
اعمال ولتاژ بایاس متناوب به پروبی که دارای پوشش فلزی است باعث میشود که بار بهصورت متناوب در لايههاي سطحي نيمههادي انباشته و خالي شده و از این طریق ظرفیت سوزن – نمونه تغییر كند. ميزان بزرگی تغيير ظرفيت با اعمال ولتاژ، اطلاعاتي را در مورد تراکم بارها فراهم میکند (دادههای دامنه در SCM)، در حاليكه اختلاف فاز بین تغییر ظرفیت و ولتاژ اعمالی(دادههای فاز در SCM)، اطلاعات حاملهای بایاس را در خصوص علامت حاملهاي بار بهصورت متناوب تغییر میدهد [1].
2- اصول كار ميكروسكوپ ظرفيتي روبشي
که در آن (Vac) ولتاژ محرک است. نیروی ظرفیتی Fcap(z) بین سوزن و سطح نمونه در پتانسیل (Vs) بهصورت زیر تعریف میشود:
دومین هارمونی نیروی ظرفیت به (dC/dz) و (Vac) وابسته است:
میکروسکوپ SCM شامل یک سوزن پروب فلزی رسانا و یک حسگر ظرفیتی فوقالعاده حساس بههمراه اجزای AFM معمولي است. در SCM همانند EFM، بین سوزن و نمونه، یک ولتاژ بهصورت ساختار MOS اعمال میشود. سوزن فلزی پروب در تماس با نمونه نیمههادي اکسیدی، یک خازن MOS را بهوجود میآورد که در آن (M) پروب فلزی، (S) ماده نيمههادی و (O) دیالکتریک نازکی است که روی سطح نیمههادي تشکیل شدهاست. در خازن MOS، الکترود فلزی که با نام گیت شناخته میشود با يك لایه اکسیدی از الکترود نیمههادی، جدا میشوند [2].
شکل (1) خازن MOS را که از سوزن SCM و نيمههادي تشکیل شدهاست، نشان میدهد. ظرفیت کل با ضخامت لایه اکسید و ضخامت لایه تخلیه تعیین میشود و به تراکم بار در زیر لایه سیلیسيم و ولتاژ (DC) اعمال شده بین سوزن و نيمههادي وابسته است. چنانچه بارهای آزاد داخل نمونه تحت تأثیر میدان الکتریکی (AC) که بهوسیله پروب رسانا اعمال میشود، قرار گیرند حرکت خواهند کرد [2]. مدار شامل ظرفیت ذخیره (Cox) و ظرفیت تخلیه (Cd) است که به ترتیب به ضخامت لایه اکسید و میزان ناخالصی وابسته هستند.
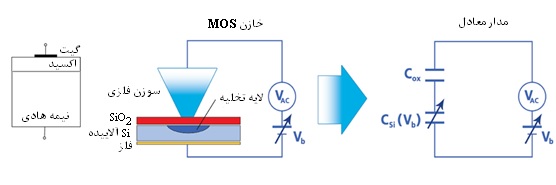
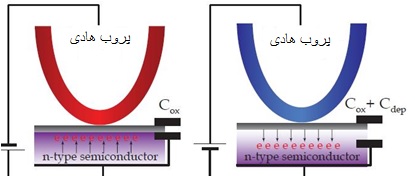
باید توجه داشت که ظرفیت بین دو صفحه با رابطه زير بهدست میآید:
در شرایط انباشتگی، بارها به سوی سطح جذب میشوند. این عمل، مشابه حرکت صفحه پایینی به سمت بالا است. بدین ترتیب، میزان جدایی صفحات (t) کاهش یافته و ظرفیت خازنی افزایش مییابد. بنابراین، برای ترکیبات نوع (n) هنگامی که ولتاژ اعمالی مثبت است، ظرفیت اندازهگیری شده بالاترین مقدار را دارد. هنگامی که ولتاژ به سوی مقادیر منفی جابهجا میشود، بهدلیل این که بارهاي آزاد از سطح رانده میشوند، ظرفیت کاهش پیدا میکند که مشابه حالتی است که در آن میزان جدایی صفحات افزایش مییابد (شکل 3) [5].
حرکت بارهاي آزاد و در نتیجه دامنه تغییرات ظرفیت خازن تابع سطح آلایندههای نمونه است که بهصورت مستقیم در زیر پروب قرار دارند. در ترکیباتی که به شدت آلاییده شدهاند، بارها نمیتوانند زیاد دور شوند، از این رو تغییر ظرفیت اندازهگیری شده بین ناحیه انباشته و ناحیه تخلیه کم است؛ برعکس، برای نمونههاي نيمههادي که اندکی آلاییده شدهاند، تغییرات ظرفیت بزرگ خواهد بود. این تغییرات و در نتیجه سیگنال اندازهگیری شده با حسگر SCM، میتواند برای مواد آلاییده در منحنی (C-V) مشاهده شود [5].
شکل (3) (سمت چپ)، منحنی (C-V) مربوط به یک ماده نوع (n) را در دو سطح مختلف ناخالصی نشان میدهد.
منحنی (C-V)، مسیر حركت بارها و یا لایه تخلیه در پاسخ به ولتاژ اعمال شده را نشان میدهد. وضعیت SCM در حالت اجرای (C-V) نشان ميدهد که با اعمال ولتاژ (δv ) متناوب بین سوزن و نمونه، تغییر ظرفیت (δC ) بهوجود خواهد آمد. همانطور که پیش از این اشاره شد، دامنه این تغییر ظرفیت، اطلاعاتی را درباره سطح ناخالصی در زیر سوزن فراهم میکند. به هرحال، ماهیت دامنه همیشه مقداری مثبت است. بنابراین، نمیتوان به سادگی و با نگاه کردن به دامنه دادههای (δC/δV ) ناخالصیهای نوع (n) و (p) را از یکدیگر تشخیص داد. (δC/δV ) هنگام تصویربرداری در حالت دامنه، برای ترکیبات نوع (n) و نوع (p) از نظر حسگر SCM، یکسان به نظر میرسند. حال اگر منحنی (C-V) را برای نيمهرسانای نوع (p) در شکل (3) (سمت راست) در نظر بگیریم، ملاحظه میشود که شیب منحنی (C-V) مثبت است. بنابراین، اگر فاز سیگنال (δC/δV) مورد تجزیه و تحلیل قرار گیرد، مشاهده میشود که یک تغییر فاز (180) درجهای بین مواد نوع (n) و (p) وجود دارد. بنابراین، با دریافت هر دو مؤلفه دامنه و فاز سیگنال (δC/δV ) از حسگر SCM، نه تنها تشخیص ميزان ناخالصی، بلکه تشخیص نوع ناخالصی نیز امکانپذیر میشود. تصاویر بهدست آمده از روبش سطح نمونه، تغییر ناخالصیها را در دو بعد نشان میدهند. هنگامیکه این تصاویر در مورد نمونههایی که با روش درست تهیه شدهاند بهدست میآید، دستیابی به تغییرات سه بعدی ناخالصیها امکانپذیر میشود [5].


در SCM سیستم شناسایی ظرفیت از سه ولتاژ مختلف استفاده میکند: ولتاژ بایاس (VDC)، ولتاژ بایاس (VAC) در محدوده (kHz) و ولتاژ بایاس (VAC) در محدوده (UHF) (در حدود 1Gz).
ولتاژ بایاس (DC) به سوزن – نمونه اعمال میشود تا سیستم را در نقطه شروع، آماده کند، ولتاژ (AC) نیز باعث نوسان سریع در محدوده (kHz) میشود. فرکانس سیگنال (AC) باید به ميزان کافی بزرگ باشد تا فرکانسهاي بالا در منحنی (C-V) حاصل شود. دامنه ولتاژ (UHF) کوچک انتخاب میشود تا با خروجی سیستم تداخل پیدا نکند. این ولتاژ تنها برای آشکارسازی سیگنالهای کوچکی که بهوسیله حسگر ظرفیت ایجاد میشوند، استفاده میشود [6].
3- آمادهسازی نمونه
هدف اصلی این مرحله، آمادهسازی ایدهآل نمونه است تا نمونهای با سطح کاملاً صاف و مسطح، لایه اکسیدی با ضخامت یکنواخت و لایههای میانی با چگالی کاهش یافته بهدست آید. دستیابی به این مشخصات برای رسیدن به نتایج تکرارپذیر برای هر نمونه ضروری است. روش استانداردی برای آمادهسازی نمونه در روش SCM تهیه شدهاست و نتایج نهایی این روش به شدت به تمیز بودن محیط و مهارتهای فردی که عملیات صیقلکاری را انجام میدهد، بستگی دارد. بهترین نتایج SCM برای نمونههای بسیار صاف با RMS کمتر از (1nm) بهدست میآید. بعد از این که نمونه کاملا تمیز شد، در مرحله بعد اکسیدهای طبیعی با استفاده از محلول آبی 1:10 فلوئوریک اسید (HF) زدوده میشود. چند قطره فلوئوریک اسید رقیق به مدت تقریبی ده ثانیه برای حذف اکسیدهای طبیعی از سطح نمونه کافی است. سپس نمونه بلافاصله با استفاده از آب یونزدایی شده و به مدت 20-30 ثانیه شسته میشود. در مرحله بعد، یک لایه اکسیدی روی سطح رشد داده میشود که برای تهیه آن میتوان اکسیداسیون را به دو روش انجام داد:
- در دمای 300⁰C در هوا و تحت تابش اشعه فرابنفش به مدت 40 دقیقه.
- در دمای 70⁰C در محیط هیدروژن پراکسید به مدت 10 دقیقه.
4- ویژگی پروبهای SCM
از دیگر ویژگی مهم پروب، سختی آن است؛ زیرا در روشهای تماسی از شکستگی پروب بههنگام روبش که باعث کاهش حساسیت سوزن و کاهش کنترل در اندازهگیری میشود، ممانعت بهعمل میآورد. اگر سوزن روکش شود، لایه پوششی، سخت از فرسودگی لایه رسانای خارجی جلوگیری میکند. لازم است که هدایت الکتریکی پروب بسیار بالا و نزدیک به هدایت فلزات باشد. قابلیت انعکاس خوب سطح فوقانی تیرک نیز برای سيستم لیزری آشکارساز نوری ضروری است.
در روش SCM، تیرک، نیرویی در حد چند نانونيوتن به سطح وارد میكند و از این رو سختی تیرک معمولاً در محدوده (N/m 5-0/1) در نظر گرفته میشود. در پروبهای SCM بهمنظور به حداقل رساندن برهمکنش الکتریکی سوزن – نمونه، بهتر است از سوزنهایی با نسبت منظر بزرگتر استفاده نمود. پروبهای تجاری در دسترس برای SCM، پروبهای سیلیسیمی با پوشش فلز و پروبهای سیلیسیمی آلاییده با پوشش الماس هستند که اولی با شعاع (nm30-10) تیزتر است ولی سریعتر ساییده میشود، در حالی که دومی با شعاع (nm100-60) ضخیمتر بوده ولی در برابر آسیبهای مکانیکی بسیار مقاومتر است. مقایسه عملی این دو نوع پروب آشکار میکند که کارایی سوزنهای با پوشش الماس در انجام روبش از نظر تکرارپذیری اندازهگیری، بسیار بالاتر است. رسانایی بالای این نوع سوزنها به دلیل مقدار زیاد بور بوده که در لایه روکش الماس آلاییده بهکار رفته است [6].
5- عوامل مؤثر بر تکرارپذیری نتایج
-
تغییر اندازه سوزن
-
نشت ظرفیت
یکی دیگر از منابع انحراف در این روش، نشت ظرفیت است که بر اثر برهمکنش بین نمونه و بدنه تیرک حاصل میشود. برای حل این مسئله، شكل هندسی دستگاه بهگونهای طراحی میشود که اتصالات پشتیبانی کننده تیرک در بالای نمونه قرار نگیرند، بلکه در نواحی جانبی آن واقع شوند. بدین ترتیب، ظرفیت نويزي بین بدنه تیرک و نمونه حذف میشود [3].
-
رطوبت محیط
با ايجاد میدان الکتریکی قوی بین سوزن و نمونه ممکن است ذرات آب موجود در سطح لایه اکسیدی تجزیه شده و باعث تزریق پروتونها (H+) به داخل این سطح شود. تزریق بار به این شکل منجر به انحراف سیگنال میشود. همچنین وجود رطوبت میتواند پدیده اکسیداسیون آندی را که در AFM و STM پدیده شناخته شدهای است، بهوجود آورد. پدیده اکسیداسیون به عواملی نظير درصد رطوبت، ولتاژ بایاس اعمالی، بایاس پلاریزاسیون، اندازه سوزن، ضخامت لایه اکسیدی و کیفیت اکسیداسیون بستگی دارد که اين عوامل میتوانند کیفیت اندازهگیری SCM را تحت تأثیر قرار دهند [3].
-
تخلیه سوزن
عامل دیگر انحراف، تخلیه سوزن است. هنگامی که عمل روبش روی نواحی به شدت آلاییده صورت میگیرد، لازم است ولتاژ بایاس قویتری اعمال شود. این ولتاژ بایاس قوی ممکن است باعث تخلیه سوزنهای از جنس سیلیسیم شده و در نتیجه منجر به انحراف سیگنال شود [3].
-
وارونگی کنتراست
یکی از موارد مورد بحث در روش SCM، وارونگی کنتراست است. در واقع باید سیگنال SCM با کاهش غلظت آلاینده در نمونه، بهصورت یکنواخت افزایش یابد. بارها مشاهده ميشود كه بههنگام كار با اين ميكروسكوپ، سیگنال SCM با افزایش غلظت آلاینده افزایش مييابد که به آن پدیده وارونگی کنتراست گفته میشود. عوامل پدید آورنده این اثر هنوز چندان مشخص نیستند [3].
-
نور لیزر
نور لیزر نیز باعث انحراف سیگنال SCM میشود و اثر نويزي در سيستم آشکارسازی دارد [3]






