آموزش پیشرفتهآموزش نانو
میکروسکوپي نیروی کلوین در بررسي خواص نانومواد-بخش اول

ميكروسكوپ نيروي كلوين شاخهاي از ميكروسكوپ پروبي روبشي است كه تصويربرداري پتانسيل سطحي محدوده وسيعي از مواد را در مقياس نانومتر ممكن ميكند. در اين روش، تفاوت پتانسيل تماسي موضعي بين سوزن هادي AFM و سطح نمونه اندازهگيري ميشود. در اين روش نقشه تابع كار يا پتانسيل سطح نمونه با توان تفكيك بالا ترسيم ميشود. ميكروسكوپ نيروي پروب كلوين یک روش منحصر بهفرد برای تشخیص و شناسایی ویژگیهای الکتریکی، فلزات و نیمههادیها ميباشد. با اين روش اطلاعات بسيار مهمي درباره توزيع پتانسيل سطحي بدست ميآيد كه در توسعه عملكرد وسايل نوري و الكتريكي بسيار با اهميت است.
این مقاله شامل سرفصلهای زیر است:
1- مقدمه
2- تاريخچه
3- میکروسکوپ نیروی اتمی
4- اصول روش کلوین
5- اصول کار میکروسکوپ پروبي نیروی کلوین و حالتهای مختلف آن
6- شبکه آزمایشگاهی فناوری راهبردی
7-نتیجهگیری
1- مقدمه
روش میکروسکوپی پروبی نیروی کلوین (KPFM) ابزاری است که امکان تصویربرداری از پتانسیل سطحی طیف گستردهای از مواد را در مقیاس نانومتر فراهم میکند. برای دستیابی به بهترین نتیجه در اندازهگیریهای KPFM لازم است جزییات دستگاه و فیزیک اندازهگیری این روش به خوبی درک شود. میکروسکوپ پروبی نیروی کلوین در سال 1991 توسط نان نماخر و همکارانش اختراع و بهعنوان شاخهای از میکروسکوپ نیروی اتمی كه یکی از شناخته شدهترین روشها در میکروسکوپهای پروبی روبشی است، بنا نهاده شد و به صورت یک روش منحصر بهفرد برای تشخیص و شناسایی ویژگیهای الکتریکی، الکترونیکی سطوح فلزی، نیمههادیها و ابزارهای نیمههادی بهطور گستردهای مورد استفاده قرار گرفته است [1]. همچنین اخیراً از این روش برای مطالعه خواص ابزارها، ترکیبات آلی و نیز ترکیبات بیولوژیکي استفاده شده است. میکروسکوپ پروبی نیروی کلوین، ابزاری است که بهوسیله آن میتوان اختلاف پتانسیل تماسی موضعی بین سوزن هادی میکروسکوپ نیروی اتمی (AFM) و نمونه را اندازهگيري نموده و از این طریق نقشه تابع کار یا پتانسیل سطحی نمونه را با توان تفکیک بسیار بالا ترسیم نمود. در این روش، تابع کار در مواد هادي، عايق و نیز پتانسیل سطحی در مقیاس نانومتر مورد سنجش قرار میگیرد. در این میکروسکوپ، روش کلوین با اصول میکروسکوپهای پروبی روبشی تلفیق شده و در نهایت روش کار دستگاه بر مبنای تصویربرداری بهوسیله روبش سطح و اندازهگیری پتانسیل آن بنا نهاده شده است. شكل 1 شماي كلي از احساس سطح نمونه بهوسيله ميكروسكوپ پروبي روبشي را نشان ميدهد [2].

از میکروسکوپ پروبی نیروی کلوین میتوان در كاربردهاي متعددی نظير موارد زير بهره گرفت:
- بررسی خواص الکتریکی نانوساختارهای فلزی [4-6]،
- تجزیه و تحلیل سطح نیمههادیها [7-17]،
- تجزیه و تحلیل توزیع بار بر روی سطح مورد نظر[18- 21 ]،
- ارزیابی پتانسیل توزیع بارالکتریکی در ترانزیستورهای اثر میدان آلی (OFETs [22-24] )،
- بررسی وتفسیر الکتروشیمیایی خوردگی سطوح [25- 26 ]،
- اندازهگیری پتانسیل سطح در غشاهای لیپیدی [27 ]،
- بررسی توزیع بار الکتریکی در نیمههادیهای بلوري[28-32].
نمودار زیر شمای سادهای از این دستگاه را ارائه میدهد.

2- تاريخچه
عملكرد میکروسکوپ پروبی نیروی کلوین، براساس تلفیقی از دو روش ميكروسكوپي نيروي اتمي و کلوین ماکروسکوپی است. بدین مفهوم که در این دستگاه اصول روش کلوین در مقیاس نانو استفاده شده که با عملکرد AFM همخوانی دارد. به منظور تفهیم بیشتر اصول کارکرد میکروسکوپ پروبی نیروی کلوین در ابتدا به نحوه عملکرد AFM اشاره شده و سپس به روش کلوین پرداخته میشود [2 و 33].
3- میکروسکوپ نیروی اتمی
چنانچه عنوان شد، میکروسکوپ پروبی نیروی کلوین بر اساس عملکرد میکروسکوپ نیروی اتمی بنا نهاده شده است. در حقیقت، با گزینش اطلاعات پتانسیل سطح یا تابع کار در نمونه، میکروسکوپ پروبی نیروی کلوین اطلاعات توپولوژی میکروسکوپ نیروی اتمی را جمع آوری مینماید. در میکروسکوپ نیروی اتمی، با روبش سطح نمونه بهوسيله سوزن ميكروسكوپ، کوچکترین پستی و بلندی سطح نمونه ثبت میشود. بسته به طبیعت برهمکنشهای موضعی، تصویری سهبعدی از خاصیت مورد نظر (ساختار الکترونیکی، ساختار مغناطیسی و غيره ) بدست میآید [33].
روش AFM در حالتهای تماسی، ضربهای و غیرتماسی عمل میکند. در حالت تماسی، نیروی دافعه میان سوزن- نمونه، سوزن تیرک را منحرف میکند. انحراف تیرک پایش شده و بهعنوان سیگنال بازخورد استفاده میشود. در حالت ضربهاي و غیرتماسی، تیرک با فرکانس تشديد و یا فرکانسی نزدیک به فرکانس تشديد نوسان داده میشود. برهمکنش سوزن – نمونه با تغییر فاصله بين سوزن و نمونه تغییر مییابد و این امر سبب میشود که دامنه نوسان و فرکانس تشديد تغییر یابد. تغییراتی که در دامنه و فرکانس روی میدهد با توجه به منبع تغییرات دامنه و فرکانس، بهعنوان سیگنالهای بازخورد برای بدست آوردن توپوگرافی سطح نمونه استفاده میشود [33].
اطلاعات خام AFM نیازمند تجزیه و تحلیل بوده و بدون تفسیر فاقد ارزش هستند لذا دستگاههای نوین AFM با استفاده از نرم افزارهای مناسب این اطلاعات را که حاوی نقاط فراوانی در دستگاههای مختصات کارتزین هستند به تصاویر سه بعدی (شکل 3) تبدیل مینمایند که در این حالت مورد استفاده محققین قرار میگیرد [33].
روش AFM در حالتهای تماسی، ضربهای و غیرتماسی عمل میکند. در حالت تماسی، نیروی دافعه میان سوزن- نمونه، سوزن تیرک را منحرف میکند. انحراف تیرک پایش شده و بهعنوان سیگنال بازخورد استفاده میشود. در حالت ضربهاي و غیرتماسی، تیرک با فرکانس تشديد و یا فرکانسی نزدیک به فرکانس تشديد نوسان داده میشود. برهمکنش سوزن – نمونه با تغییر فاصله بين سوزن و نمونه تغییر مییابد و این امر سبب میشود که دامنه نوسان و فرکانس تشديد تغییر یابد. تغییراتی که در دامنه و فرکانس روی میدهد با توجه به منبع تغییرات دامنه و فرکانس، بهعنوان سیگنالهای بازخورد برای بدست آوردن توپوگرافی سطح نمونه استفاده میشود [33].
اطلاعات خام AFM نیازمند تجزیه و تحلیل بوده و بدون تفسیر فاقد ارزش هستند لذا دستگاههای نوین AFM با استفاده از نرم افزارهای مناسب این اطلاعات را که حاوی نقاط فراوانی در دستگاههای مختصات کارتزین هستند به تصاویر سه بعدی (شکل 3) تبدیل مینمایند که در این حالت مورد استفاده محققین قرار میگیرد [33].
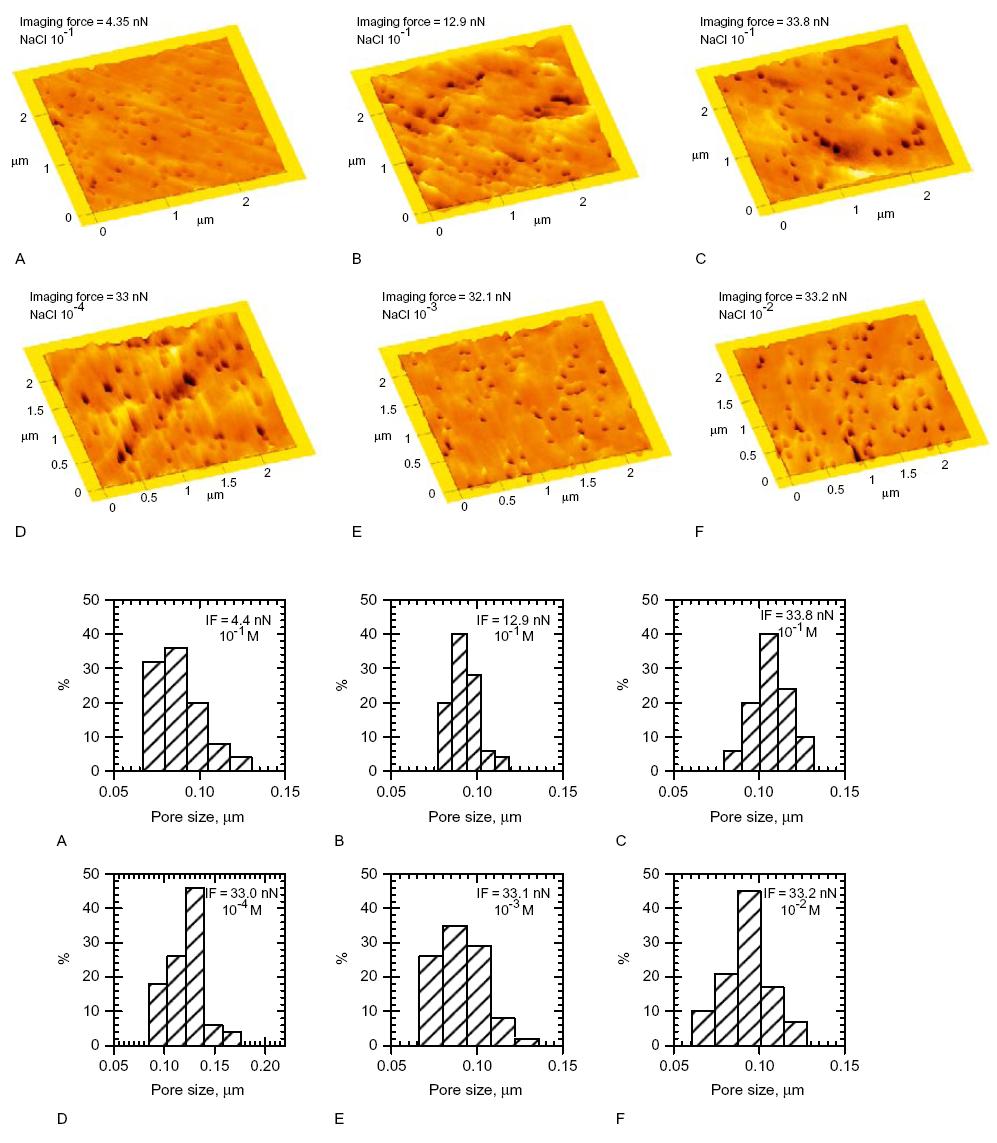
4- اصول روش کلوین
این روش حدود صد سال پیش توسط لرد کلوین ارائه شد [1و34] كه در این روش میزان تابع کار در فلزات و پتانسیل سطح در غیر فلزات با دقتی حدود0/0001 ولت اندازه گیری میشود. تابع کار در دو سطح اتمي و مولكولي مشاهده شده و بدین ترتیب نقشه تابع كار كه شامل اطلاعاتي دربارة تركيب و حالات الكتريكي ساختارهاي موضعي روي سطوح جامد است، بدست میآید. تابع کار، میزان کار مورد نیاز جهت انتقال الکترونهای لایه ظرفیت یک اتم است .
بهمنظور درک بیشتر مطلب لازم است تا نکاتی در خصوص اربیتالهای مولکولی و تراز فرمی عنوان شود . در تشکیل یک مولکول، الکترونهای اتمهای تشکیلدهنده آن در اوربیتالهای مولکولی قرار میگیرند. اوربیتال مولکولی حاصل ادغام و یا تفاضل توابع موج دو یا چند اوربیتال اتمی است. اوربیتالهای مولکولی را به دو نوع پیوندی و ضدپیوندی تقسیمبندی میکنند. اگر برهمکنش بین اوربیتالهای اتمی از نوع برهمکنش سازنده باشد، در این صورت توابع موج مربوط به اتمها با يكدیگر جمع میشود و اوربیتال مولکولی حاصل شده از نوع پیوندی است. اگر برهمکنش بین اوربیتالهای اتمی از نوع برهمکنش غیرسازنده یا مخرب باشد در این صورت تفاضل توابع موج مربوط به اتمها از يكدیگر در نظر گرفته میشود و اوربیتال مولکولی حاصل شده از نوع ضدپیوندی است. در شیمی بر حسب سطح انرژی اوربیتالهای مولکولی بالاترین اوربیتال مولکولی دارای الکترون را HOMO و پایینترین اوربیتال مولکولی فاقد الکترون را LUMO مینامند. شکل 4 شمایی از این اربیتالها را به نشان ميدهد. چنانچه ملاحظه میشود در این شکل تراز فرمی حد واسط دو اربیتال مولکولی HOMO و LUMO قرار گرفته است [35].
بهمنظور درک بیشتر مطلب لازم است تا نکاتی در خصوص اربیتالهای مولکولی و تراز فرمی عنوان شود . در تشکیل یک مولکول، الکترونهای اتمهای تشکیلدهنده آن در اوربیتالهای مولکولی قرار میگیرند. اوربیتال مولکولی حاصل ادغام و یا تفاضل توابع موج دو یا چند اوربیتال اتمی است. اوربیتالهای مولکولی را به دو نوع پیوندی و ضدپیوندی تقسیمبندی میکنند. اگر برهمکنش بین اوربیتالهای اتمی از نوع برهمکنش سازنده باشد، در این صورت توابع موج مربوط به اتمها با يكدیگر جمع میشود و اوربیتال مولکولی حاصل شده از نوع پیوندی است. اگر برهمکنش بین اوربیتالهای اتمی از نوع برهمکنش غیرسازنده یا مخرب باشد در این صورت تفاضل توابع موج مربوط به اتمها از يكدیگر در نظر گرفته میشود و اوربیتال مولکولی حاصل شده از نوع ضدپیوندی است. در شیمی بر حسب سطح انرژی اوربیتالهای مولکولی بالاترین اوربیتال مولکولی دارای الکترون را HOMO و پایینترین اوربیتال مولکولی فاقد الکترون را LUMO مینامند. شکل 4 شمایی از این اربیتالها را به نشان ميدهد. چنانچه ملاحظه میشود در این شکل تراز فرمی حد واسط دو اربیتال مولکولی HOMO و LUMO قرار گرفته است [35].
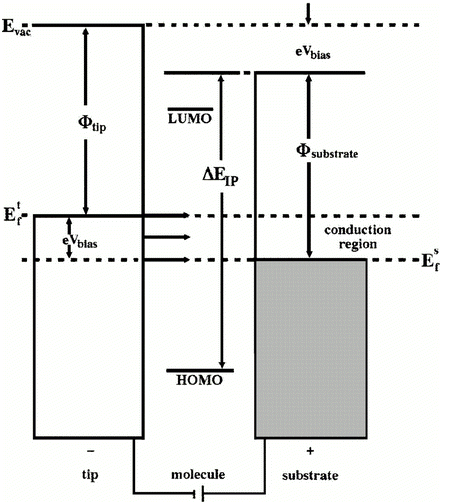
با توجه بیشتر به این شکل مشخص میشود که تابع کار، اختلاف بین انرژی سطح فرمی و بالاترین سطح ممکن در سیستم است. در صورتی که یک تماس خارجی بین دو فلز برقرار شود جریانی از الکترونها از تراز فرمی مشابه بوجود میآید که این جریان الکترونی، اختلاف پتانسیل تماسی (CPD ) بین این دو سطح (وقتی که این دو سطح به یک میزان و در جهت خلاف یکدیگر باردار شوند) را ایجاد مینماید. در صورت اعمال ولتاژ بایاس به این صفحات، این جریان الکترونی متوقف شده و اختلاف پتانسیل تماسی حذف میشود. این ولتاژ اضافی معادل میزان تابع کار (در فلزات ) و یا پتانسیل نمونه (در نیمه هاديها) است[35].
بر این اساس اختلاف پتانسیل تماسي(VCPD) بین سوزن هادی AFM و نمونه که در روش KPFM اندازهگیری میشود، به صورت زیر تعریف خواهد شد:

که در آن Фsample و Фtip بهترتیب توابع کار نمونه و سوزن بوده و e بار الکتریکی است. هنگامی که سوزن به نزدیکی سطح نمونه آورده میشود، همان طور که گفته شد، بدلیل اختلاف بین سطوح انرژی فرمی این دو، بین سوزن و سطح نمونه نیروی الکتریکی بوجود میآید.
شکل5 دیاگرام سطح انرژی سوزن و سطح نمونه را هنگامی که Фsample و Фtip متفاوت هستند، در سه حالت نشان میدهد. شکل 5-a سطوح انرژی سوزن و سطح نمونه را هنگامی که با فاصله d از هم جدا هستند و بهصورت الکتریکی بهيكديگر متصل نیستند را نشان میدهد (توجه داشته باشید که سطوح خلاء هم تراز هستند ولی سطوح انرژی فرمی متفاوت هستند). چنانچه سوزن و سطح نمونه برای تونلزنی الکترونی به اندازه کافی به یکدیگر نزدیك شوند، برای رسیدن به وضعیت تعادل لازم است سطوح فرمی در وضعیت پایداری قرار گیرند. با برقرار شدن تماس الکتریکی، سطوح فرمی از طریق جریان الکتریکی تراز میشوند و سامانه به وضعیت تعادلی (شکل 5-b) میرسد. سوزن و سطح نمونه باردار شده و اختلاف پتانسیل VCPD به صورت واضحی بهوجود میآید (با توجه به این که سطوح انرژی فرمی تراز میشوند ولی سطوح انرژی خلاء دیگر همان سطوح انرژی نمیباشند، بدین ترتیب VCPD بین سوزن و سطح نمونه شکل میگیرد). در ناحیه تماس بدلیل وجود VCPD، یک نیروی الکتریکی فعال میشود. همانطور که در شکل 5-c نشان داده شده است، چنانچه یک ولتاژ بایاس خارجی (VDC) به همان بزرگی و در جهت مخالف VCPD اعمال شود، این نیرو میتواند خنثی شود. ولتاژ اعمال شده بارهای سطحی را در ناحیه تماس حذف میکند. مقدار ولتاژ بایاس خارجی اعمال شده (VDC) که میتواند نیروی الکتریکی ناشی از VCPD را بیاثر کند، برابر اختلاف تابع کار بین سوزن و نمونه است، بنابراین هنگامی که تابع کار سوزن معلوم است، تابع کار نمونه میتواند محاسبه شود [2].
شکل5 دیاگرام سطح انرژی سوزن و سطح نمونه را هنگامی که Фsample و Фtip متفاوت هستند، در سه حالت نشان میدهد. شکل 5-a سطوح انرژی سوزن و سطح نمونه را هنگامی که با فاصله d از هم جدا هستند و بهصورت الکتریکی بهيكديگر متصل نیستند را نشان میدهد (توجه داشته باشید که سطوح خلاء هم تراز هستند ولی سطوح انرژی فرمی متفاوت هستند). چنانچه سوزن و سطح نمونه برای تونلزنی الکترونی به اندازه کافی به یکدیگر نزدیك شوند، برای رسیدن به وضعیت تعادل لازم است سطوح فرمی در وضعیت پایداری قرار گیرند. با برقرار شدن تماس الکتریکی، سطوح فرمی از طریق جریان الکتریکی تراز میشوند و سامانه به وضعیت تعادلی (شکل 5-b) میرسد. سوزن و سطح نمونه باردار شده و اختلاف پتانسیل VCPD به صورت واضحی بهوجود میآید (با توجه به این که سطوح انرژی فرمی تراز میشوند ولی سطوح انرژی خلاء دیگر همان سطوح انرژی نمیباشند، بدین ترتیب VCPD بین سوزن و سطح نمونه شکل میگیرد). در ناحیه تماس بدلیل وجود VCPD، یک نیروی الکتریکی فعال میشود. همانطور که در شکل 5-c نشان داده شده است، چنانچه یک ولتاژ بایاس خارجی (VDC) به همان بزرگی و در جهت مخالف VCPD اعمال شود، این نیرو میتواند خنثی شود. ولتاژ اعمال شده بارهای سطحی را در ناحیه تماس حذف میکند. مقدار ولتاژ بایاس خارجی اعمال شده (VDC) که میتواند نیروی الکتریکی ناشی از VCPD را بیاثر کند، برابر اختلاف تابع کار بین سوزن و نمونه است، بنابراین هنگامی که تابع کار سوزن معلوم است، تابع کار نمونه میتواند محاسبه شود [2].
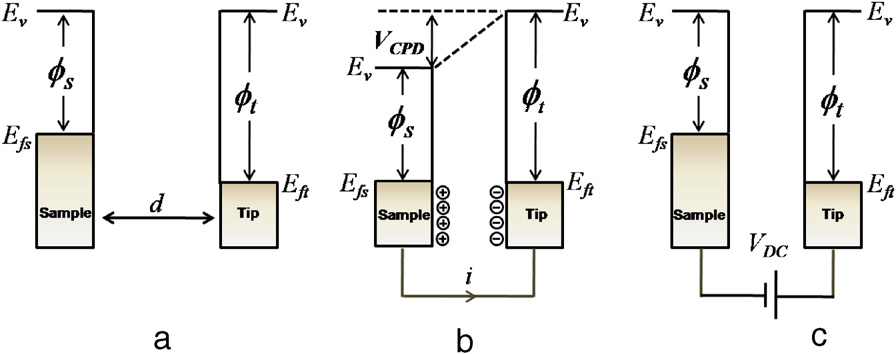
با اعمال ولتاژ AC (VAC) به همراه ولتاژ DC (VDC) به سوزن ، تابع کار نمونه میتواند بهوسیله روش KPFM اندازهگیری شود. VAC نیروهای نوسانی الکتریکی بین سوزن و سطح نمونه را بوجود میآورد و VDC نیروهای الکتریکی نوسانی که از CPD بین سوزن و سطح نمونه سرچشمه میگیرد را حذف میکند. نیروی الکترواستاتیک (Fes) بین سوزن و نمونه از رابطه زیر بدست میآید [36]:
(1) 

که در آن z جهت نرمال سطح نمونه، ΔV اختلاف پتانسیل بین VCPD و ولتاژ اعمال شده به سوزن و dC/dz گرادیان ظرفیت بین سوزن و سطح نمونه است. هنگامی که ولتاژ VAC sin(ωt)+VDC به سوزن اعمال میشود، اختلاف ولتاژ ΔV بهصورت زیر تعریف می شود:
(2) 

توجه داشته باشید که علامت ± بستگی دارد به این که آیا ولتاژ بایاس (VDC) اعمال شده به نمونه (+) یا
(-) است. با ادغام دو معادله بالا، عبارت زیر برای نیروی الکترواستاتیکی که به سوزن وارد می شود، بدست میآید:
(-) است. با ادغام دو معادله بالا، عبارت زیر برای نیروی الکترواستاتیکی که به سوزن وارد می شود، بدست میآید:
(3) 

این معادله میتواند به سه جزء تقسیم شود :

در عبارت نخست، FDC نتیجه انحراف ثابت سوزن است. در عبارت دوم Fω با فرکانس ω برای اندازگیری VCPD استفاده میشود و در عبارت سوم، F2ω میتواند در روش میکروسکوپی ظرفیت استفاده شود[37]. هنگامی که نیروهای الکترواستاتیک از طریق VAC و VDC به سوزن اعمال میشود، (به دلیل نیروی الکتریکی) مؤلفههای نوسانی اضافی به نوسان مکانیکی سوزن اضافه میشود. از یک تقویتکننده قفلشونده برای اندازهگیری VCPD استفاده میشود تا مؤلفه نیروی الکتریکی با فرکانس ω (Fω)، تابع VCPD و VAC بدست آیند. سیگنال خروجی تقویتکننده قفلشونده با اختلاف بین VCPD و VDC مستقیماً متناسب است. چنانچه سیگنال خروجی تقویتکننده قفلشونده خنثی شده و Fω برابر صفر شود، مقدار VCPD میتواند بهوسیله اعمال ولتاژ VDC به سوزن اندازهگیری شود. در نتیجه مقدار VDC برای هر نقطه روی سطح نمونه بدست آمده و نقشه تابع کار یا پتانسیل سطحی را برای کل مساحت سطح نمونه بوجود میآورد [36-37].
5- اصول کار میکروسکوپ پروبي نیروی کلوین و حالتهای مختلف آن
چنانچه قبلاً نیز عنوان شد، اساس کار میکروسکوپ نیروی اتمی با روش کلوین تلفیق شده و منجر به ایجاد روش میکروسکوپ نیروی کلوین گردید.
میکروسکوپ نیروی اتمی طراحی شده و مورد استفاده قرار گرفت ولی بهمرور ویژگیهای دیگری مانند یک مولد سیگنال که سیگنال الکتریکی ولتاژ AC را بهکار میگیرد، نیز بدان اضافه شد. این سیگنال معادل فرکانس تشديد پایه سوزن است. البته با این طراحی نمیتوان پایه سوزن را به تشديد وادار نمود ( مشابه آنچه که در ضربهزنی AFM روی میدهد). در واقع این اختلاف پتانسیل بین ولتاژ AC در پایه سوزن و ولتاژ DC در سطح ( پتانسیل سطح یا تابع کار ) است که موجب ارتعاش پایه سوزن میشود. ولتاژ بایاس AC با ایجاد اختلاف پتانسیل بین سوزن و نمونه موجب فركانس تشديد پایه سوزن میشود. یک جریان خنثی در سیستم میکروسکوپ نیروی کلوین تنظیمات این ولتاژ AC را بعهده دارد تا اپراتور دستگاه متوجه این مهم گردد که ارتعاش سوزن ناشی از پتانسیل سطح است یا این که تابع کار در نمونه این ارتعاش را ایجاد نموده است. ولتاژ AC اعمال شده بر سوزن بهعنوان تصویر ثبت و ضبط میشود. هر گونه انحراف در پایه سوزن تابعی از مجموع نیروهایی است که بین نمونه و سوزن دستگاه وجود دارد. رابطه بین این تراکنشهای انرژی با معادله زیر بیان میشود:
میکروسکوپ نیروی اتمی طراحی شده و مورد استفاده قرار گرفت ولی بهمرور ویژگیهای دیگری مانند یک مولد سیگنال که سیگنال الکتریکی ولتاژ AC را بهکار میگیرد، نیز بدان اضافه شد. این سیگنال معادل فرکانس تشديد پایه سوزن است. البته با این طراحی نمیتوان پایه سوزن را به تشديد وادار نمود ( مشابه آنچه که در ضربهزنی AFM روی میدهد). در واقع این اختلاف پتانسیل بین ولتاژ AC در پایه سوزن و ولتاژ DC در سطح ( پتانسیل سطح یا تابع کار ) است که موجب ارتعاش پایه سوزن میشود. ولتاژ بایاس AC با ایجاد اختلاف پتانسیل بین سوزن و نمونه موجب فركانس تشديد پایه سوزن میشود. یک جریان خنثی در سیستم میکروسکوپ نیروی کلوین تنظیمات این ولتاژ AC را بعهده دارد تا اپراتور دستگاه متوجه این مهم گردد که ارتعاش سوزن ناشی از پتانسیل سطح است یا این که تابع کار در نمونه این ارتعاش را ایجاد نموده است. ولتاژ AC اعمال شده بر سوزن بهعنوان تصویر ثبت و ضبط میشود. هر گونه انحراف در پایه سوزن تابعی از مجموع نیروهایی است که بین نمونه و سوزن دستگاه وجود دارد. رابطه بین این تراکنشهای انرژی با معادله زیر بیان میشود:

در معادله فوق، ارتباط بین انرژی و ولتاژ خازن بیان شده است که در آن C ظرفیت خازن ،V ولتاژ AC یا DC و ω فرکانس تشديد است. در اغلب موارد بهمنظور بالا بردن حساسیت دستگاه، سیگنال AC را در حدود فرکانس تشديد ثانویه تنظیم می کنند [36-37و33].
همانطور که قبلاً توضیح داده شد، AFM میتواند علاوه بر حالت تماسی، در دو حالت ضربهاي و غیرتماسی نیز نیروهای اتمی را آشکار نماید. در KPFM نیروی الکترواستاتیک Fω میتواند بهوسیله این دو حالت آشکارسازی شود. حالت نوسانی در KPFM میتواند Fω را مستقیماً از دامنه نوسان تیرک در ω که بهوسیله VCPD و VAC القا میشود، اندازهگیری کند. برای این منظور، VDC به سوزن اعمال میشود تا دامنه اندازهگیری شده را خنثی نموده و از این طریق VCPD را اندازهگیری نمايد. در حالت غیرتماسی روش KPFM، Fω بهوسیله جابهجایی فرکانس در ω آشکار میشود وVDC به سوزن اعمال میشود تا جابهجایی فرکانس را خنثی کرده و بدین ترتیب VCPD را اندازهگیری نماید [38].
علاوه بر این، در روش KPFM میتوان با استفاده از سوزن AFM توپوگرافی و VCPD را بهصورت همزمان اندازهگیری نمود. بنابراین لازم است از یک روش خاص برای جداسازی سیگنال مربوط به توپوگرافی از سیگنال مربوط به VCPD اندازهگیری شده، استفاده شود. در دستگاه KPFM، معمولاً VAC در فرکانسی بالاتر از پهنای باند سامانه بازخورد توپوگرافی تنظیم میشود تا از تداخل میان اندازهگیری توپوگرافی و CPD جلوگیری شود. در حالت ضربهاي روش KPFM، توپوگرافی بهوسیله نوسان در نخستین فرکانس تشديد سوزن اندازهگیری میشود و VCPD بهوسیله دامنه نوسان در فرکانس تشديد دوم سوزن بدست میآید. تیرکی که بهصورت مکانیکی ارتعاش مییابد، معمولاً دارای چندین پیک تشديد در طیف دامنه – فرکانس نوسان میباشد. معمولاً دومین پیک تشديد دارای پهنای بیشتری نسبت به پیک فرکانس تشديد اول است. دامنه پیک تشديد دوم معمولاً از یک سوم پیک فرکانس تشديد اول کمتر است و فرکانس پیک تشديد دوم معمولاً 6 برابر فرکانس تشديد اول است. VAC در فرکانس رزنانس دوم تنظیم میشود تا بتواند سوزن را با نیروی الکتریکی برانگیخته کند، در حالی که از فرکانس تشديد اول برای کنترل ارتفاع سوزن استفاده میشود. با استفاده از این روشها، توپوگرافی و سیگنال VCPD میتوانند از یکدیگر جدا شوند. برعکس، در حالت غیرتماسی، سوزن به صورت مکانیکی در فرکانس تشديد اول برانگیخته میشود. VAC باعث القا مدولاسیون نیروی الکترواستاتیک میشود که بهوسیله افزوده شدن نوسان در تغییر فرکانس نوسان مکانیکی سوزن آشکار شده و باعث جدا شدن توپوگرافی و سیگنال VCPD میشود [38- 39].
توان تفکیک فضایی در اندازه گیری VCPD در حالت نوسان فرکانس از حالت نوسان دامنه به مراتببالاتر است. در روش KPFM نیروی الکتروستاتیک در حالت نوسان دامنه و بوسیله نوسان تیرک آشکار می شود در حالی که در نوسان فرکانس ،گرادیان نیروی الکتروستاتیک با جابجائی فرکانس تیرک تشخیص داده می شود. به هر حال محدوده تشخیص گرادیان نیرو کوچکتر از خود نیرو است [39].
آشکارسازی نیروی الکترواستاتیک بهعنوان آشکارسازی دوربرد در نظر گرفته میشود، در حالی که آشکارسازی گرادیان نیروی الکترواستاتیک کوتاه برد است. در روش KPFM برهمکنش الکترواستاتیکی (ناشی از نوسان دامنه )، اساساً بین نوک سوزن و سطح نمونه روی میدهد و از این رو در این حالت، توان تفکیکی فضایی تقریباً معادل ابعاد نوک سوزن است. اما در حالت نوسان فرکانس، برهمکنش الکترواستاتیک سوزن و تیرک با نمونه از رویه آشکارسازی دوربرد تبعیت مینماید و توان تفکیک فضایی بر اثر تأثیر متقابل متوسط سوزن و تیرک کاهش مییابد [36-39].
بههر حال، با اندازهگیری پتانسیل سطحی در این روش میتوان اطلاعات زیر را از این دستگاه بدست آورد :
علاوه بر این، در روش KPFM میتوان با استفاده از سوزن AFM توپوگرافی و VCPD را بهصورت همزمان اندازهگیری نمود. بنابراین لازم است از یک روش خاص برای جداسازی سیگنال مربوط به توپوگرافی از سیگنال مربوط به VCPD اندازهگیری شده، استفاده شود. در دستگاه KPFM، معمولاً VAC در فرکانسی بالاتر از پهنای باند سامانه بازخورد توپوگرافی تنظیم میشود تا از تداخل میان اندازهگیری توپوگرافی و CPD جلوگیری شود. در حالت ضربهاي روش KPFM، توپوگرافی بهوسیله نوسان در نخستین فرکانس تشديد سوزن اندازهگیری میشود و VCPD بهوسیله دامنه نوسان در فرکانس تشديد دوم سوزن بدست میآید. تیرکی که بهصورت مکانیکی ارتعاش مییابد، معمولاً دارای چندین پیک تشديد در طیف دامنه – فرکانس نوسان میباشد. معمولاً دومین پیک تشديد دارای پهنای بیشتری نسبت به پیک فرکانس تشديد اول است. دامنه پیک تشديد دوم معمولاً از یک سوم پیک فرکانس تشديد اول کمتر است و فرکانس پیک تشديد دوم معمولاً 6 برابر فرکانس تشديد اول است. VAC در فرکانس رزنانس دوم تنظیم میشود تا بتواند سوزن را با نیروی الکتریکی برانگیخته کند، در حالی که از فرکانس تشديد اول برای کنترل ارتفاع سوزن استفاده میشود. با استفاده از این روشها، توپوگرافی و سیگنال VCPD میتوانند از یکدیگر جدا شوند. برعکس، در حالت غیرتماسی، سوزن به صورت مکانیکی در فرکانس تشديد اول برانگیخته میشود. VAC باعث القا مدولاسیون نیروی الکترواستاتیک میشود که بهوسیله افزوده شدن نوسان در تغییر فرکانس نوسان مکانیکی سوزن آشکار شده و باعث جدا شدن توپوگرافی و سیگنال VCPD میشود [38- 39].
توان تفکیک فضایی در اندازه گیری VCPD در حالت نوسان فرکانس از حالت نوسان دامنه به مراتببالاتر است. در روش KPFM نیروی الکتروستاتیک در حالت نوسان دامنه و بوسیله نوسان تیرک آشکار می شود در حالی که در نوسان فرکانس ،گرادیان نیروی الکتروستاتیک با جابجائی فرکانس تیرک تشخیص داده می شود. به هر حال محدوده تشخیص گرادیان نیرو کوچکتر از خود نیرو است [39].
آشکارسازی نیروی الکترواستاتیک بهعنوان آشکارسازی دوربرد در نظر گرفته میشود، در حالی که آشکارسازی گرادیان نیروی الکترواستاتیک کوتاه برد است. در روش KPFM برهمکنش الکترواستاتیکی (ناشی از نوسان دامنه )، اساساً بین نوک سوزن و سطح نمونه روی میدهد و از این رو در این حالت، توان تفکیکی فضایی تقریباً معادل ابعاد نوک سوزن است. اما در حالت نوسان فرکانس، برهمکنش الکترواستاتیک سوزن و تیرک با نمونه از رویه آشکارسازی دوربرد تبعیت مینماید و توان تفکیک فضایی بر اثر تأثیر متقابل متوسط سوزن و تیرک کاهش مییابد [36-39].
بههر حال، با اندازهگیری پتانسیل سطحی در این روش میتوان اطلاعات زیر را از این دستگاه بدست آورد :
- پتانسیل سطحی موضعی بهعنوان نتیجه تأثیر متقابل مولکولهای دوقطبی (گروههایی با سرهای قطبی )
- تفاوت ثابتهای دیالکتریک
- میزان نازکی لایههای روکشدار شده
- نقشه خوردگی سطح فلزات
- اطلاع از تفاوت اختلاف پتانسیل سطحی در نیمههادیها ،ترانزیستورها ، LED و غيره
- آگاهی یافتن از نقشه پتانسیل سطح [4و36-39]
شکل 6 شماي دستگاه آزمایشگاهی KPFM را نشان میدهد. بخش پایینی سامانه حالتهای نوسان در دامنه و فرکانس را برای اندازهگیری توپوگرافی نشان میدهد و بخش بالایی اجزای ترسیم نقشه CPD را که شامل کنترلکننده KPFM و تقویتکننده قفلشونده است، نشان میدهد. خط نقطه چین و خط توپر در دیاگرام، نشاندهنده آرایش حالتهای نوسان در دامنه وفرکانس در روش KPFM هستند. در این روش Vac از تقویتکننده قفلشونده به سوزن اعمال شده و خروجی سیگنال ولتاژ (خروجی OSC) را بازگشت میدهد. در حالت غیرتماسی، جابهجایی سیگنال فرکانس (Δf) به دو شاخه ارسال میشود: یکی به تنظیمکننده Z برای رسم توپوگرافی میرود و دیگری به تقویتکننده قفلشونده فرستاده شده كه اين تقویت کننده، سیگنال را با همان فرکانس Vac استخراج کرده و به کنترلکننده KPFM میفرستد. کنترلکننده ، با اعمال Vdcبه سوزن، این بازخورد را برای خنثی کردن سیگنال خروجی تقویتکننده قفلشونده نگه میدارد. در حالت نوسانی، Vac با همان فرکانس و بهعنوان پیک تشديد دوم نوسان سوزن، به سوزن اعمال میشود تا سوزن را با نیروی الکتریکی برانگیخته کند. دامنه نوسان سوزن دارای دو مؤلفه است: فرکانس پایین (پیک تشديد اول) که بهوسیله نوسان مکانیکی تنظیم میشود و فرکانس بالا (پیک تشديد دوم) که بهوسیله Vac تنظیم میشود. فيلتر میانی سیگنالهای با فرکانس بالا و پایین را از یکدیگر جدا میکند. سیگنال با فرکانس پایین برای تنظیم توپوگرافی استفاده میشود. فرکانس با تشديد بالا مستقیماً به تقویتکننده قفلشونده فرستاده میشود. کنترلکننده KPFM، با استفاده از مؤلفه فرکانس تشديد دوم، CPD را اندازهگیری میکند [40].

6- شبکه آزمایشگاهی فناوری راهبردی
این مقاله از مجموعه مقالات فصل نامه شبکه آزمایشگاهی فناوریهای راهبردی سال 2013، شماره 2 برگرفته شده است. برای دسترسی به مراکز خدمات دهنده AFM بر روی لینک زیر کلیک کنید [60].
| نام دستگاه |
| میکروسکوپ نیروی اتمی |
7- نتیجهگیری
در دهه گذشته، روش KPFM به منظور برقراری ارتباط بین علوم سطح / مواد و صنعت نیمههاديها توسعه و گسترش یافت. روش KPFM نسبت به ویژگیهای سطح بسیار حساس است . همچنین این روش میتواند اطلاعات بسیار مهمی را درباره توزیع پتانسیل سطحی در اختیار بگذارد که در ارتقاء کارایی دستگاههای الکترونیکی و نوری کارساز است. بهدلیل تطبیقپذیری روش KPFM در شناسایی خواص الکتریکی – الکترونیکی سطح و ابزارهای در حال کار، به نظر میرسد این روش در آینده توسط محققین مورد استفاده قرار گيرد. به هر حال برای کاربرد وسیعتر این روش با توان تفکیک اتمی، لازم است اصول فیزیک و بهویژه برهمکنشهای الکترواستاتیک بین سوزن و نمونه در مقیاس اتمی بیشتر روشن شده و مورد بررسي قرار گیرد [2].
منابـــع و مراجــــع
۱ – [1] M. Nonnenmacher, M.P. Oboyle, H.K. Wickramasinghe, Appl. Phys. Lett. 58 (1991) 2921.
۲ – 2) W. Melitz, J.Shen, A. C. Kummel, S.b Lee, Surface Science Reports 66 (2011) 1–27.
۳ – 3) www.tut.fi.
۴ – 4) C. Sommerhalter, T. Glatzel, T.W. Matthes, A. Jager-Waldau, M.C. Lux-Steiner, Appl. Surf. Sci. 157 (2000) 263.
۵ – 5) C.Barth , C.R. Henry, Nanotechnology 17 (2006) S155.
۶ – 6) T. Glatzel, S. Sadewasser, R. Shikler, Y. Rosenwaks, M.C. Lux-Steiner, Mat. Sci.Eng. B 102 (2003) 138.
۷ – 7) G.H. Enevoldsen, T. Glatzel, M.C. Christensen, J.V. Lauritsen, F. Besenbacher, Phys. Rev. Lett. 100 (2008) 236104.
۸ – 8) T. Arai, M. Tomitori, Phys. Rev. Lett. 93 (2004) 256101.
۹ – 9) K. Okamoto, K. Yoshimoto, Y. Sugawara, S. Morita, Appl. Surf. Sci. 210 (2003).128.
۱۰ – 10) S. Kitamura, M. Iwatsuki, Appl. Phys. Lett. 72 (1998) 3154.
۱۱ – S. Kitamura, K. Suzuki, M. Iwatsuki, C.B. Mooney, Appl. Surf. Sci. 157 (2000) 222.
۱۲ – K. Okamoto, Y. Sugawara, S. Morita, Appl. Surf.Sci.188 (2002) 381.
۱۳ – A. Sasahara, C.L. Pang, H. Onishi, J. Phys. Chem. B 110 (2006) 17584.
۱۴ – S. Sadewasser, P. Jelinek, C.K. Fang, O. Custance, Y. Yamada, Y. Sugimoto, M. Abe, S. Morita, Phys. Rev. Lett. 103 (2009) 266103.
۱۵ – K. Nakayama, T. Shiota, Surf. Interface Anal. 40 (2008) 885.
۱۶ – Y. Sugawara, T. Uchihashi, M. Abe, S. Morita, Appl. Surf. Sci. 140 (1999) 371.
۱۷ – A. Huijser, J. Vanlaar, T.L. Vanrooy, Surf. Sci. 62 (1977) 472.
۱۸ – T. Miyazaki, K. Kobayashi, K. Ishida, S. Hotta, T. Horiuchi, K. MatsushigeH. Yamada; J.Appl.Phys., 2005, 97, 124503
۱۹ – L. Burgi, H. SirringhausR. H. Friend, Appl.Phys. Lett., 2002, 80, 2913.
۲۰ – K. P. Puntambekar, P. V. Pesavento,C. D. Frisbie, Appl. Phys.Lett., 2003, 83, 5539.
۲۱ – V. Palermo, M. Palma, P. Samori, Adv. Mater. 2006, 18, 145.
۲۲ – D. Fichou, J. Mater. Chem. 2000, 10, 571.
۲۳ – D. Byron, A. Mataharu, R. Wilson, G. Wright, Mol. Cryst. Liq. Cryst. 1995, 265, 61.
۲۴ – V. de Cupere, J. Tant, P. Viville, R. Lazzaroni, W. Osikowicz, W. R. Salaneck, Y. H. Geerts, Langmuir, 2006, 22, 7798.
۲۵ – A. Abbadie, G. Hamaide, D. Mariolle, M. Chaupin, F. Brunier, E. Martinez,J. Mähliß .,J. Appl. Phys. 111, 064912 (2012)
۲۶ – Patrick Mesquida, Andreas Stemmer; Microelectronic Engineering 61–62 (2002) 671–674
۲۷ – 27) Z. Leonenko . Langmuir 22:10135-10139
۲۸ – 28) UMUT BOSTANCI;DEVELOPMENT OF ATOMIC FORCE MICROSCOPY SYSTEMKELVIN PROBE MICROSCOPY SYSTEM FOR USE IN SEMICONDUCTOR NANOCRYSTAL CHARACTERIZATION, THESIS, AUGUST 2007
۲۹ – Y. Rosenwaks, R. Shikler, T. Glatzel, S. Sadewasser, Phys. Rev. B 70 (2004) 085320
۳۰ – S. Saraf, Y. Rosenwaks ; Surface Science 574 (2005) L35–L39
۳۱ – S. Belaidi, P. Girard, G. Leveque, J. Appl. Phys. 81 (1997) 1023
۳۲ – T.Takahashi , T. Matsumoto, S. Ono ; Ultramicroscopy109(2009)963–967
۳۳ – W.Richard Bowen,N.Hilal, Atomic Force Microscopy ,Elsevier 1st edition 2009
۳۴ – Principles of the Kelvin Probe Force Microscopy, I.R. Jankov, I.D. Goldman, R.N. Szente, Revista Brasileira de Ensino de Fsica, vol. 22, no. 4, Dezembro, 2000.
۳۵ – 35) Leanna C. Giancarloand George W. Flynn ,Annual Review of Physical Chemistry Vol. 49: 297-336, 1998.
۳۶ – 36) R. Shikler, T. Meoded, N. Fried, B. Mishori, Y. Rosenwaks, J. Appl. Phys. 86 (1999) 107.
۳۷ – 37) S.V. Kalinin, A. Gruverman (Eds.), Scanning Probe Microscopy, Springer, New York, 2007.
۳۸ – 38) T. Glatzel, S. Sadewasser, M.C. Lux-Steiner, Appl. Surf. Sci. 210 (2003) 84.
۳۹ – 39) U. Zerweck, C. Loppacher, T. Otto, S. Grafstrom, L.M. Eng, Phys. Rev. B 71 (2005) 125424.
۴۰ – L. Nony, F. Bocquet, C. Loppacher, T. Glatzel, Nanotechnology 20 (2009) 264014.
۴۱ – 41) F. Krok, K. Sajewicz, J. Konior, M. Goryl, P. Piatkowski, M. Szymonski, Phys. Rev. B 77 (2008) 235427.
۴۲ – 42) C. Barth, C.R. Henry, J. Phys. Chem. C 113 (2009) 247.
۴۳ – 43) H.J. Leamy, J. Appl. Phys. 53 (1982) R51.
۴۴ – S. Gunther, B. Kaulich, L. Gregoratti, M. Kiskinova, Prog. Surf. Sci. 70 (2002) 187.
۴۵ – 45) J.C. Gonzalez, K.L. Bunker, P.E. Russell, Appl. Phys. Lett. 79 (2001) 1567.
۴۶ – H. Luth, Solid Surfaces, InterfacesThin Films, 4th ed., Springer, Berlin, 2001.
۴۷ – W. Monch, Semiconductor SurfacesInterfaces, 2nd ed., Springer, Berlin, 1995.
۴۸ – 48) D.P. Woodruff, T.A. Delchar, Modern Techniques of Surface Science, Cambridge University Press, Cambridge, 1986.
۴۹ – 49) S. Sadewasser, C. Leendertz, F. Streicher, M.C. Lux-Steiner, Nanotechnology 20 (2009).
۵۰ – K.Yagi, M. Fujihira , Applied Surface Science 157:405-411
۵۱ – T.Goodman .Langmuir 20:3684:3689.
۵۲ – C.R. Henry, Appl. Surf. Sci. 164 (2000) 252.
۵۳ – M. Goryl, J.J. Kolodziej, F. Krok, P. Piatkowski, B. Such, M. Szymonski, Microelectron. Eng.81 (2005) 394.
۵۴ – H.G. Boyen, et al., Science 297 (2002) 1533.
۵۵ – L. Gross, F. Mohn, P. Liljeroth, J. Repp, F.J. Giessibl, G. Meyer, Science 324
۵۶ – C. Barth, C.R. Henry, Appl. Phys. Lett. 89 (2006) 252119.
۵۷ – M.R. Hoffmann, S.T. Martin, W.Y. Choi, D.W. Bahnemann, Chem. Rev. 95 (1995) 69.
۵۸ – 58) A. L. Linsebigler, G.Q. Lu, J.T. Yates, Chem. Rev. 95 (1995) 735.
۵۹ – 59) A. Sasahara, K.Hiehata, H. Onishi, Catal. Surv. Asia 13 (2009) 9.
۶۰ – فصل نامه شبکه آزمایشگاهی فناوریهای راهبردی سال 2013 و شماره 2






